10nmプロセスの実現に光、EUVリソグラフィ技術に進展:課題は山積だが、着実に前進(2/2 ページ)
ムーアの法則からは、それ始めている
スループットの問題を解決できたとしても、EUVには、化学増幅レジスト(CAR:Chemical-amplified Resist)のための新しい材料を開発しなくてはならないという課題がある。さらに、マスクの欠陥をなくすためにペリクルも開発する必要がある。最先端のEUV装置の開発は、もともとは2007年に実用化される見込みだったので、既に7年の後れが出ている状態だ。
それでも、Ronse氏は楽観的な姿勢を崩さない。「道のりは長いが、少しずつ前進している」(同氏)。ASMLは、2014年末までに80Wの光源を導入する予定だ。「2015年末には160〜180Wの光源を実現できる可能性がある。コスト効果の高い量産体制の実現には十分な強さの光源だ」(Ronse氏)。
Intelは、10nmプロセスのチップをEUVを使わずに製造する、コスト効率の高い方法があることをほのめかしている。だが同社は、マルチレイヤーパターニングなどについては言及していない。
Ronse氏は、「EUV以外では、現実的な代替プランはない」と述べる。トリプルパターニングやクアッドパターニングでは、アラインメントやフォーカス制御、OPC(Optical Proximity Correction:光近接効果補正)にコストがかかりすぎる上に、複雑な工程になってくるからだ。「このような膨大なコストに耐えられるメーカーなどない。ムーアの法則に沿うことは、もうできなくなっている」(同氏)。
Synopsysの共同CEOであるAart de Geus氏も、「ムーアの法則によって、より高性能、より安価なチップを提供し続けられるかどうかは、定かではない」と語っている。
de Geus氏は、プロセスの微細化については慎重な姿勢を見せる。「われわれは初めて、ムーアの法則のカーブからそれ始めている。マルチレイヤーパターニングは大幅なコスト増となり、そのプロセスではとても製造を維持できない」(同氏)。
遅れる450mmウエハーへの移行
IMEC Technology Forumのセッションで、ASMLのVan den Brink氏は、EUVについて楽観的な見解を示しつつ、コストを引き下げる鍵となる450mmウエハーの開発を急ぐ必要があると述べた。同氏は、「450mmウエハーへの移行時期は、大幅に遅れている」と述べ、大口径ウエハーへの移行における課題を指摘した。
【翻訳:田中留美、編集:EE Times Japan】
関連記事
 EUVは本当に実用化できるのか?
EUVは本当に実用化できるのか?
半導体製造技術のロードマップでは、193nmリソグラフィに限界が来たら、157nmフォトリソグラフィへと移行するはずだった。しかし、実際に普及したのは193nmの液浸リソグラフィであった。次の技術として名前が挙がるのはEUVだが、「この技術が実際に商業用途で利用されるかどうかは定かではない」と指摘する声がある。 ムーアの法則はもう限界? リソグラフィ技術開発が追い付かず
ムーアの法則はもう限界? リソグラフィ技術開発が追い付かず
半導体の技術革新の源となってきたムーアの法則だが、さすがに限界が見え始めている。その原因の1つがリソグラフィ技術開発の遅れだ。 想像以上に難しい14nmプロセス、設計面での課題が山積
想像以上に難しい14nmプロセス、設計面での課題が山積
14nmプロセス技術を確立することは、設計者たちが予想していたよりも、はるかに難しいようだ。プロセスの微細化が進むに連れて、リーク電流の増加などの課題が浮き彫りになった。IBMのエンジニアは、「14nm世代では、これまでの対応策が通用しなくなる」との見解を述べている。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 重量はクジラ級! 超巨大な高NA EUV装置の設置をIntelが公開
- JDI、次世代有機ELディスプレイ「eLEAP」を24年12月に量産開始へ
- 2023年の世界半導体売上高ランキングトップ20、NVIDIAが初の2位に
- 中国政府の「Intel/AMD禁止令」、中国企業への強い追い風に
- パワー半導体向けウエハー市場、2035年に1兆円台へ
- Intelが高NA EUV装置の組み立てを完了、Intel 14Aからの導入に向けて前進
- 全固体ナトリウム電池の量産化に向けた新合成プロセスを開発、大阪公立大
- 「GPT-4」を上回る性能で、グラフィカルな文書を読解するLLM技術
- わずか3個のLSIでモバイル超音波診断装置を実現、ソシオネクスト
- TSMC、24年Q1は増収増益 地震の影響は「最小限にとどまる」

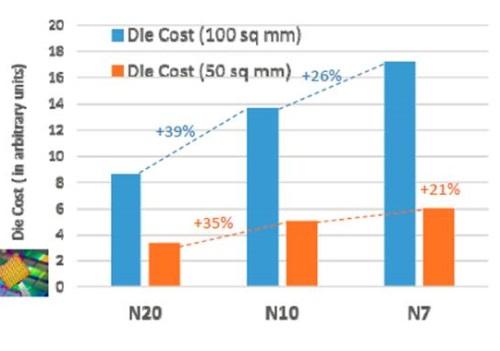 EUVを使わなければ、チップの製造コストは大幅に上がっていく
EUVを使わなければ、チップの製造コストは大幅に上がっていく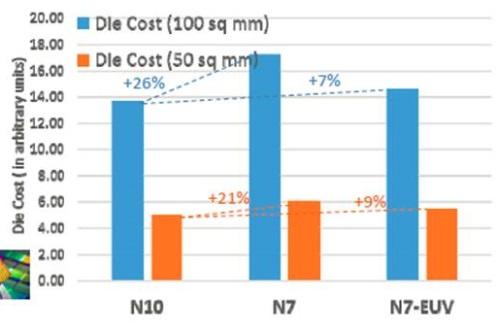 EUVを導入できれば、コストの増加は許容できる範囲まで抑えられる
EUVを導入できれば、コストの増加は許容できる範囲まで抑えられる