IBMがEUVのスループットで記録更新、1日637ウエハー:プロセス技術 EUV
IBMは2014年7月、ASML製の最新のEUV(極端紫外線)リソグラフィシステムの試験初日に「予想以上の結果を得た」と発表した。スキャナー「NXE3300B」に44Wの光源を用いて、安定した速度(34ウエハー/時)を保って、24時間で637枚のウエハーを作り出したという。
IBMは2014年7月、ASML製の最新のEUV(極端紫外線)リソグラフィシステムの試験初日に「予想以上の結果を得た」と発表した。スキャナー「NXE3300B」に44Wの光源を用いて、安定した速度(34ウエハー/時)を保って、24時間で637枚のウエハーを作り出したという。ウエハーサイズは直径300mm。
EUVリソグラフィは次世代チップに必要な高品位印刷パターンの技術として最有力視されているが、その複雑さのために、10年以上も研究段階にとどまってきた。IBMの最新の試験結果でさえも、7nmノードの実現はいまだ期待できないという。7nmノードの生産開始は2020年以降となる見込みだ。
「1日800ウエハーも」
試験の初日、米国ニューヨーク州アルバニーにあるIBMの研究施設に設置されたNXE3300Bの稼働時間は77%に及んだ他、部分的なダイを含むウエハー全体で83イメージフィールド/ウエハーにわたって20mJ(ミリジュール)の照射量を実現した。IBMのEUV開発プロジェクトのマネージャであるDan Corliss氏は「途中で何度か中断しなければ、1日で800ウエハー以上のウエハーを生産できただろう」と述べた。
なお、以前のIBM製EUVシステムで1日に露光できるウエハーはわずか7ウエハーだった。
Corliss氏のチームは2カ月間、スキャナーの調整に取り組んできた。スキャナーは2013年11月に初めてコンポーネントの中に設置された。当初の光源は25Wだった。
相対的に弱い光源では大量生産に必要な最低限のスループット(100ウエハー/時)を実現できないため、EUVシステムの主要課題の1つだった。Corliss氏によると、IBMは今後約6カ月でASML製のスキャナーで80Wの光源を得ることを目指しているという。
まだまだ大量生産段階ではない
Corliss氏は「これまで12年もの間この技術に取り組んできたわれわれにとって、今回の試験結果はうれしい驚きである。同時に、業界全体と共有すべき素晴らしい達成でもある。とはいえ、大量生産段階に入ったとはいえない。大量生産を実現するにはいまだ数多くの課題が残されている」と述べた。
IBMは現在、時折発生する光源が使えなくなる現象の原因を調査中である他、マスク欠陥などEUVが直面する障害や課題の解決にも取り組んでいる。
【翻訳:青山麻由子、編集:EE Times Japan】
- FD-SOIがついに大規模量産で日の目を見るのか? STの戦略を読み解く
- 次世代組み込みプロセッサ向け18nmプロセス技術、FD-SOIと相変化メモリがベース
- 生合成した共重合体とのブレンドで、ポリ乳酸の靭性と生分解性を改善
- 浮体式ペロブスカイト太陽電池の共同実証実験を東京都北区のプールで開始
- 「M3 MacBook Air」は衝撃的なファンレスモバイル Windowsの世界よりも2歩先を進んでいる
- TSMCの詳細判明、台湾地震による半導体工場の最新被害/稼働状況
- 「3D NANDの進化」に必要な要素とは
- 「必要な性能の半導体が欲しいときに入手できない」、企画力向上急ぐ
- 「30年に3000億円規模」のシリコンキャパシター市場、後発ロームが見いだす勝機とは
- ST、次世代「STM32」マイコンに向けたプロセス技術を発表
関連記事
 IBMが今後5年間で3000億円を半導体開発に投資
IBMが今後5年間で3000億円を半導体開発に投資
IBMは、7nm以降の半導体微細加工技術と、シリコンに代わる新材料によるチップデバイス技術の開発を主とした研究開発を実施すると発表した。今後、5年間で30億米ドル(約3000億円)を投資するという。 IBMの歴史
IBMの歴史
チーズスライサーや計算機を扱っていたIBMは、コンピュータ/PC市場に参入し、「帝国」と呼ばれるまでに成長した。今でこそ大規模な人員削減を行っている同社だが、コンピュータ業界における軌跡は、“帝国”と呼ばれるにふさわしい。 FinFET以降の半導体製造技術はどう進む? IBMの見解
FinFET以降の半導体製造技術はどう進む? IBMの見解
「Common Platform Technology Forum」において、IBMが半導体製造技術の将来展望について発表を行った。液浸リソグラフィによるダブルパターニング技術やFD-SOI技術に加え、カーボンナノチューブ、シリコンフォトニクス、ナノワイヤーなどのキーワードを交えて半導体製造の将来像や課題などが示された。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 2023年の世界半導体売上高ランキングトップ20、NVIDIAが初の2位に
- 中国政府の「Intel/AMD禁止令」、中国企業への強い追い風に
- 就業人員の4割が帰還組、ルネサス甲府工場が10年の時を経て再稼働
- 日本伝統の「和装柄」がヒントに 半導体の高度な熱管理につながる技術
- ルネサス甲府工場がいよいよ再稼働 柴田社長「パワー半導体の戦略的拠点に」
- Raspberry PiがAIカメラモジュール発売へ、ソニーのAI処理機能搭載センサー採用
- 半導体製造装置の販売額、2023年は1063億ドルで前年比1.3%減
- 「FinFETの終えん」に備える 今後10年でGAAへの移行が加速?
- Rapidus、シリコンバレーに新会社設立 AI半導体の顧客開拓を加速
- 2024年はDRAM/NAND市場が回復へ 需給バランスも正常化

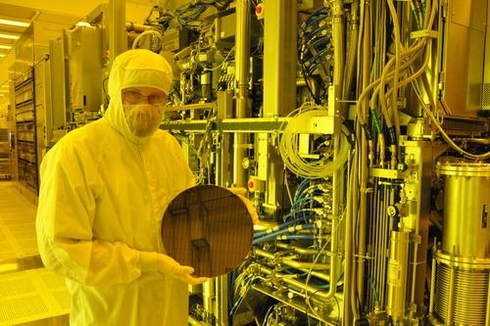 試験の様子 出典:IBM
試験の様子 出典:IBM