GaNウエハー結晶面のゆがみ、素早く詳細に評価:結晶欠陥の局所的分布を可視化
物質・材料研究機構(NIMS)は、GaN(窒化ガリウム)ウエハー結晶面のゆがみを、素早くかつ詳細に可視化できる新たな手法を開発した。
物質・材料研究機構(NIMS)は2018年5月、GaN(窒化ガリウム)ウエハー結晶面のゆがみを、素早くかつ詳細に可視化できる新たな手法を開発したと発表した。
GaNは、シリコンに比べ高耐圧で省電力などの特長を持つことから、EV用モーターの制御回路や5G(第5世代移動通信)システム向けの高周波デバイスといった用途で注目されている。しかし、現状では結晶欠陥などデバイスの特性にかかわる課題もあり、結晶面の品質を適切に評価することが不可欠であるが、従来の評価手法だと「測定に時間がかかる」「詳細な情報が得られない」といった問題があった。
結晶面の形状を約30分で評価
そこで研究チームは、新たな評価手法を開発した。GaNウエハーを回転させ2方向以上からX線の回析強度を測定し、数学的に解析する手法である。これにより結晶面全体の「ゆがみの方向」と「大きさ」を一度に、定量的に可視化することができる。大型放射光施設「Spring-8」のシンクロトロンX線を用いて、直径が2インチのGaNウエハーを評価した。これによると、数十μmの空間分解能で一度に結晶面の形状を可視化でき、約30分で結晶品質を評価することができたという。
評価に用いた試料は、GaNウエハーに厚み3μmでGaNを成長させている。試料の全面にほぼ単色平行のX線を照射し、結晶格子面から回析が生じるように、X線の入射角を調整した。入射X線と試料表面の角度は約0.6度である。さらに、回折強度が最大となる入射角0.6度付近で、入射角を25秒単位で変えて、その回析像を2次元X線検出器で測定した。こうした方法で、試料を表面法線周りに120度回転させ、測定を繰り返し行った。
測定の結果は、結晶面にゆがみがあれば、その方向を「矢印」で示す。ゆがみがなければ矢印ではなく「点」で表示される。測定に用いた試料には矢印が見られ、局所的なゆがみがあることが分かった。矢印の傾きの絶対値を見ることで、ゆがみの分布も分かるという。解析結果から、今回の試料は、±0.03度の範囲でゆがみがあると判断した。
NIMSは今後、パワーデバイスの特性とGaNウエハーにおける結晶面形状との関係性などについて研究を進める予定だ。
関連記事
 有機電子光デバイス用高分子、新合成法を開発
有機電子光デバイス用高分子、新合成法を開発
筑波大学と物質・材料研究機構(NIMS)の共同研究グループは、有機電子光デバイス用高分子半導体を合成するための新しい合成技術を開発した。作製した高分子が、有機EL素子の発光材料として機能することも確認した。 酸化マンガンをグラフェンで挟んだ負極材料開発
酸化マンガンをグラフェンで挟んだ負極材料開発
物質・材料研究機構(NIMS)の研究グループは、二次電池の高容量化と長寿命化の両立を可能とする酸化物/グラフェン複合材料を開発した。 TDKら、高誘電率材料の設計システムを開発
TDKら、高誘電率材料の設計システムを開発
ファインセラミックスセンターとTDK、京都大学、物質・材料研究機構(NIMS)らの研究チームは、マテリアルズインフォマティクス手法を応用して、高誘電率材料を設計するためのシステムを開発した。 NIMS、磁場のみで動作するトランジスタ開発
NIMS、磁場のみで動作するトランジスタ開発
物質・材料研究機構(NIMS)は、磁気でイオンを輸送するという、これまでとは異なる原理で動作するトランジスタを開発した。 分子を用いた縦型共鳴トンネルトランジスタ
分子を用いた縦型共鳴トンネルトランジスタ
物質・材料研究機構(NIMS)らの研究グループは、分子を量子ドットとして用いた縦型共鳴トンネルトランジスターを作製し、その動作を実証することに成功した。 磁性絶縁体を用いグラフェンのスピン方向を制御
磁性絶縁体を用いグラフェンのスピン方向を制御
量子科学技術研究開発機構(QST)らの研究チームは、グラフェン回路を用いたスピントランジスタの実現に欠かすことができない、電子スピンの向きを制御する技術を開発した。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 2023年の世界半導体売上高ランキングトップ20、NVIDIAが初の2位に
- 中国政府の「Intel/AMD禁止令」、中国企業への強い追い風に
- 就業人員の4割が帰還組、ルネサス甲府工場が10年の時を経て再稼働
- 日本伝統の「和装柄」がヒントに 半導体の高度な熱管理につながる技術
- ルネサス甲府工場がいよいよ再稼働 柴田社長「パワー半導体の戦略的拠点に」
- Raspberry PiがAIカメラモジュール発売へ、ソニーのAI処理機能搭載センサー採用
- 半導体製造装置の販売額、2023年は1063億ドルで前年比1.3%減
- 「FinFETの終えん」に備える 今後10年でGAAへの移行が加速?
- Rapidus、シリコンバレーに新会社設立 AI半導体の顧客開拓を加速
- 2024年はDRAM/NAND市場が回復へ 需給バランスも正常化


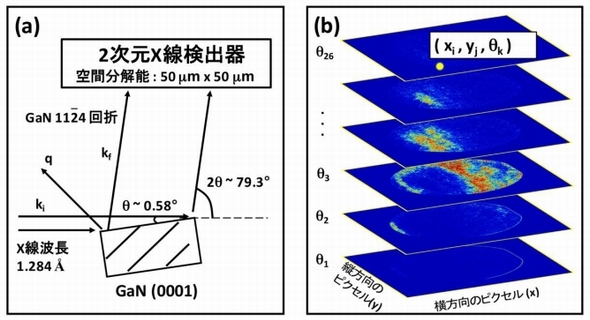 新たに開発した測定手法の概要 出典:NIMS
新たに開発した測定手法の概要 出典:NIMS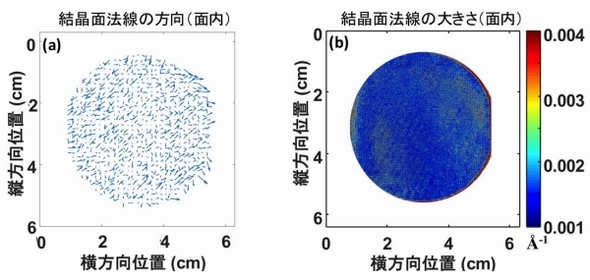 左が2インチGaNウエハーの結晶面におけるゆがみ方向。右はその大きさを濃淡で表示した例 出典:NIMS
左が2インチGaNウエハーの結晶面におけるゆがみ方向。右はその大きさを濃淡で表示した例 出典:NIMS 結晶面のゆがみを定量的に表示した例 出典:NIMS
結晶面のゆがみを定量的に表示した例 出典:NIMS