光変調器の試作例(電界吸収(EA)変調器)とまとめ(前編):福田昭のデバイス通信(153) imecが語る最新のシリコンフォトニクス技術(13)(2/2 ページ)
電界吸収変調器(EA変調器)がゲルマニウムシリコン化合物を使う理由
シリコンフォトニクスではシリコンを基板とする。光変調用の半導体材料には、シリコン基板に成長しやすいゲルマニウムとシリコンの化合物(GeSi)を使う。シリコンの単元素材料を使わないのには理由がある。シリコンではバンドギャップ(バンドギャップ)が広すぎるのだ。
データセンターなどで使う超高速光伝送には普通、波長が1550nmの光ビームを使う。これはバンドギャップだと、約0.8eV(エレクトロンボルト)に相当する。これに対してシリコン半導体のバンドギャップは室温で約1.11eVであり、基礎吸収端の波長(光を吸収する最も長い側の波長)は約1100nmとなる。つまり、波長1550nmの光をシリコンは吸収しない。
そこで、バンドギャップがシリコンよりも狭い、ゲルマニウム(Ge)の利用を考える。ゲルマニウムのバンドギャップは室温で約0.67eVであり、基礎吸収端の波長に換算すると約1850nmとなる。1550nmの光は波長が1850nmよりも短いので、ゲルマニウムが吸収する。
ゲルマニウムとシリコンの化合物であるGeSi半導体は、GeとSiの組成比を変えることによって吸収端を約1850nmから約1100nmまで調整できる。シリコン基板にGeSi半導体を成長させることは比較的容易なので、電界吸収変調器ではGeSi半導体のフランツケルディッシュ(Franz-Keldysh)効果を利用して変調(光吸収)を制御する。
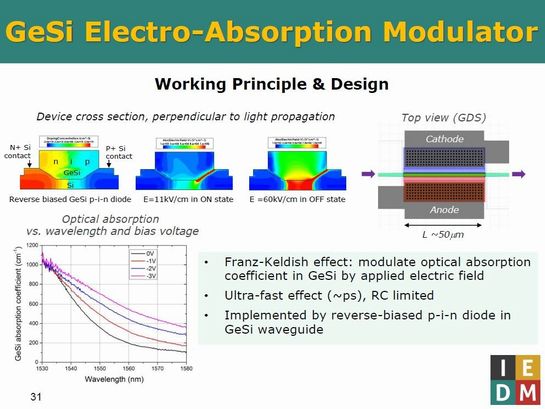 電界吸収変調器(EA変調器)の構造と特性。左上はEA変調器の断面構造図。Si光導波路薄膜の上に、GeSi薄膜のpin接合ダイオード兼光導波路を形成して光吸収層とする。右上はEA変調器の平面図。変調器の長さは約50μm。左下はGeSiダイオードの光吸収係数(縦軸)と光波長(横軸)の関係。バイアス電圧(逆バイアスなので符号はマイナス)を強く加えると、光の吸収が大きくなる。出典:imec(クリックで拡大)
電界吸収変調器(EA変調器)の構造と特性。左上はEA変調器の断面構造図。Si光導波路薄膜の上に、GeSi薄膜のpin接合ダイオード兼光導波路を形成して光吸収層とする。右上はEA変調器の平面図。変調器の長さは約50μm。左下はGeSiダイオードの光吸収係数(縦軸)と光波長(横軸)の関係。バイアス電圧(逆バイアスなので符号はマイナス)を強く加えると、光の吸収が大きくなる。出典:imec(クリックで拡大)実際の試作例を見てみよう。Siの光導波路の上にGeSi半導体の光変調薄膜を成長させ、p型とi型、n型のpin接合を形成する。このGeSi半導体のpin接合ダイオードに逆方向のバイアス電圧を外部から加えることで、光の吸収量を制御する。
フランツケルディッシュ効果を利用した電界吸収変調器の最大の特長は、効果が非常に素早く現れることだ。遅延時間は数ピコ秒にすぎない。このため、フランツケルディッシュ効果が現れるまでの遅延時間ではなく、変調器の寄生容量と寄生抵抗で決まる時定数(RC)が、変調器の速度を制限する。
もう1つの特長は、変調器の外形寸法が比較的小さいことだ。必要とされる長さは50μm前後である。リング変調器の直径10μmよりは大きいものの、シリコンフォトニクスとしては十分に許容できる寸法に収まっている。
(後編に続く)
⇒「福田昭のデバイス通信」連載バックナンバー一覧
関連記事
 シリコンフォトニクスで使われる主な光変調器
シリコンフォトニクスで使われる主な光変調器
前回、光信号の振幅や位相などを連続的に変化させるデバイス「光変調器」の基礎を説明した。今回からは、光変調器の具体的な解説に入る。 光送受信モジュールの技術開発ロードマップ
光送受信モジュールの技術開発ロードマップ
今回は、実装技術と光送受信モジュール技術のロードマップを解説する。光送受信モジュールの高速化と広帯域化では、波長分割多重(WDM)技術が重要になってくる。 超電導人工原子で巨大光シフトを観測、量子計算に進展
超電導人工原子で巨大光シフトを観測、量子計算に進展
情報通信研究機構(NICT)らの研究グループは、超電導人工原子と光子の相互作用によって生じる、極めて大きなエネルギー変化(光シフト)を、実験によって初めて観測した。 イメージング、パワー…… これから注目の技術/座談会編3
イメージング、パワー…… これから注目の技術/座談会編3
IHS Markit Technologyのアナリスト5人がエレクトロニクス業界の未来を語り合う座談会編。第3回は、今、注目の技術について語ってもらう。 光損失10分の1、変換効率5倍の半導体光変調器
光損失10分の1、変換効率5倍の半導体光変調器
東京大学と技術研究組合光電子融合基盤技術研究所(PETRA)が共同で、従来のシリコン光変調器に比べ光損失が10分の1、変換効率が5倍の半導体光変調器を開発した。 複数人を同時測定できる24GHzバイタルセンサー
複数人を同時測定できる24GHzバイタルセンサー
アナログ・デバイセズとサクラテックは2018年6月6日、24GHzレーダーを使用した非接触型バイタルセンサーシステムを共同開発したと発表した。同システムは、生体情報データを活用した先進アルゴリズム開発、研究用途などに向けた開発用プラットフォームとして販売する。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 重量はクジラ級! 超巨大な高NA EUV装置の設置をIntelが公開
- JDI、次世代有機ELディスプレイ「eLEAP」を24年12月に量産開始へ
- 2023年の世界半導体売上高ランキングトップ20、NVIDIAが初の2位に
- 中国政府の「Intel/AMD禁止令」、中国企業への強い追い風に
- パワー半導体向けウエハー市場、2035年に1兆円台へ
- どうする? EVバッテリー リサイクルは難しい、でもリユースにも疑問
- 「GPT-4」を上回る性能で、グラフィカルな文書を読解するLLM技術
- Intelが高NA EUV装置の組み立てを完了、Intel 14Aからの導入に向けて前進
- 全固体ナトリウム電池の量産化に向けた新合成プロセスを開発、大阪公立大
- Intelの最新AI戦略と製品 「AIが全てのタスクを引き継ぐ時代へ」
