KLA-Tencor、28nm/20nmプロセス向けの半導体フォトマスク検査装置を発表:プロセス技術
28nm世代以降のプロセス技術では、フォトマスク上のナノレベルの欠陥でさえも歩留まりに影響することがある。KLA-Tencorは、28nm世代以降のプロセスのレチクルを監視する検査装置を発表した。
米国の半導体装置メーカーであるKLA-Tencorは2012年9月5日、台湾の台北で開催された半導体関連の国際展示会「Semicon Taiwan 2012」(2012年9月5〜7日)で、オーバーレイ制御やフォトマスク検査用の新しい装置を発表した。
半導体製造技術が28nm世代以降になると、マルチパターニングの利用が大きくなる。マルチパターニングは、ウエハー上の回路密度を拡張するリソグラフィ技術だが、オーバーレイ誤差やマスク欠陥の新たな原因にもなっている。
今回KLA-Tencorが発表したオーバーレイ計測システム「Archer 500」は、マルチパターニングを採用した28nmノード以降の半導体の量産向けに設計されている。Archer 500は、オーバーレイ誤差を計測および解析することで、精度と計測速度を高めた。また、薄膜レジスト層や不透明なハードマスクなどの新材料にも対応できるという。
KLA-Tencorのマーケティング部門でシニアディレクタを務めるBecky Howland氏は、「ダブルやトリプル、さらに4重以上のマルチレイヤーパターニング技術を適用するには、非常に厳密なオーバーレイ仕様が必要となる。Archer 500はレイヤー上や対レイヤー、レイヤー内の誤差を計測し、微細なノードの半導体製造において正確なリソグラフィオーバーレイ制御を可能にする」と説明している。
KLA-Tencorはまた、28nmノード以降の高性能なフォトマスク検査向けの新しい検査装置も発表した。今回発表されたのは、「X5.2」と「Teron 611」の2機種のレチクル検査システムで、X5.2は、28nm世代以降のクリティカルマスク(と20nm世代以降のノンクリティカルマスク)の欠陥やパターン劣化を検出する。Teron 611は、20nm世代以降のクリティカルマスクの検査向けに設計されている。
KLA-Tencorのマーケティング部門でシニアディレクタを務めるWilbert Odisho氏は、「28nm世代以降の微細なフォトマスクパターンによる半導体製造、およびこれらのフォトマスクに対する新しいクリーニングプロセスを行うために、ファブではレチクル監視向けの新たな装置が必要とされている」と述べている。
28nm世代より前のノードでは、製造環境でフォトマスクを繰り返し使用することによって発生する微小な欠陥を考慮する必要はなかった。しかし、28nm世代以降は、マスク上のナノレベルの欠陥でさえも、歩留まりに影響を及ぼす。X5.2とTeron 611を併用すれば、28nm世代以降の半導体フォトマスクの完璧な品質再評価システムとして、欠陥やパターン劣化を監視できるという。さらに、KLA-Tencorの第5世代検査システム「STARlight」を使えば、マルチ/シングルダイレチクルの両方に対して、フォトマスクのエッジや側壁部分、オープン領域の欠陥を検出できる。
【翻訳:滝本麻貴、編集:EE Times Japan】
- Intelが高NA EUV装置の組み立てを完了、Intel 14Aからの導入に向けて前進
- 重量はクジラ級! 超巨大な高NA EUV装置の設置をIntelが公開
- FD-SOIがついに大規模量産で日の目を見るのか? STの戦略を読み解く
- 次世代組み込みプロセッサ向け18nmプロセス技術、FD-SOIと相変化メモリがベース
- 生合成した共重合体とのブレンドで、ポリ乳酸の靭性と生分解性を改善
- 浮体式ペロブスカイト太陽電池の共同実証実験を東京都北区のプールで開始
- 「M3 MacBook Air」は衝撃的なファンレスモバイル Windowsの世界よりも2歩先を進んでいる
- TSMCの詳細判明、台湾地震による半導体工場の最新被害/稼働状況
- 「3D NANDの進化」に必要な要素とは
- 「必要な性能の半導体が欲しいときに入手できない」、企画力向上急ぐ
関連記事
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 中国政府の「Intel/AMD禁止令」、中国企業への強い追い風に
- 2023年の世界半導体売上高ランキングトップ20、NVIDIAが初の2位に
- JDI、次世代有機ELディスプレイ「eLEAP」を24年12月に量産開始へ
- 重量はクジラ級! 超巨大な高NA EUV装置の設置をIntelが公開
- 全固体ナトリウム電池の量産化に向けた新合成プロセスを開発、大阪公立大
- パワー半導体向けウエハー市場、2035年に1兆円台へ
- Intelが高NA EUV装置の組み立てを完了、Intel 14Aからの導入に向けて前進
- わずか3個のLSIでモバイル超音波診断装置を実現、ソシオネクスト
- TSMC、24年Q1は増収増益 地震の影響は「最小限にとどまる」
- 全固体Liイオン電池用フッ化物固体電解質を開発

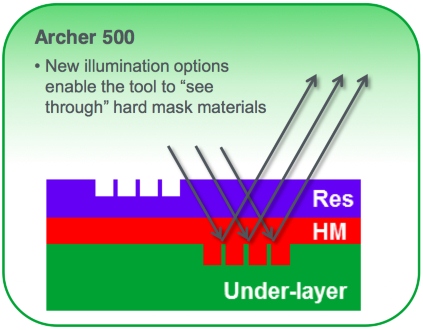 Archer 500は、薄いレジストスタックや不透明なハードマスクといった新材料を含む、新しいリソグラフィレイヤーのオーバーレイ測定に対応する。
Archer 500は、薄いレジストスタックや不透明なハードマスクといった新材料を含む、新しいリソグラフィレイヤーのオーバーレイ測定に対応する。