EE Times Japan >
プロセス技術 >
着実に進歩するEUV、課題は光源:7nmプロセスでの実用化は可能なのか(2/2 ページ)
» 2016年01月28日 11時30分 公開
[Rick Merritt,EE Times]
DRAM工場のスループット向上にも期待
EUV装置は、ナノメートル単位で極めて高い精度を達成することができるという点において優れている。しかし、スループットや信頼性など、多くの面で後れを取っていることから、開口数を向上させて、5nmまたは3nmの線幅で使用できるようにする必要があるといえる。Van Hout氏は、「ASMLは現在、利害関係者との間で、EUV装置の構造やタイミングなどの詳細について話し合いを進め、性能向上の実現に向けた対策を講じているところだ」と述べている。
同氏は、EUV装置を使用しているDRAM工場の配置図を示しながら、「EUV技術は、工場のスループットを高め、プロセス工程を29〜32%削減することによって、生産量を7〜9%増加させることが可能だ」と主張する。既存の液浸装置で、16nm以降のプロセス技術で求められる微細なパターンを実現するには、ウエハーを何回も露光する必要がある。
ISSにおいて、IM Flash Technologiesの共同CEOであるGuy Blalock氏は、「われわれは、DRAMの製造におけるEUVリソグラフィについて、今後2〜3年以内に大きな決断を下すだろう」と述べた。同社は、IntelとMicron Technologyが2006年に設立したベンチャー企業である。
同氏は、「理論的には、EUV技術を使えば、生産性を15%向上できる。2018年には、EUVは、もはや無視できなくなるほどの技術になっているだろう」と語った。
【翻訳:田中留美、編集:EE Times Japan】
関連記事
 IEDMで発表されていた3D XPointの基本技術(前編)
IEDMで発表されていた3D XPointの基本技術(前編)
米国で開催された「ISS(Industry Strategy Symposium)」において、IntelとMicron Technologyが共同開発した次世代メモリ技術「3D XPoint」の要素技術の一部が明らかになった。カルコゲナイド材料と「Ovonyx」のスイッチを使用しているというのである。この2つについては、長い研究開発の歴史がある。前後編の2回に分けて、これらの要素技術について解説しよう。 3D XPoint、開発から製造へ
3D XPoint、開発から製造へ
IntelとMicron Technologyが開発した「3D XPoint」は、製造の段階へと移る見込みだ。量産には12〜18カ月かかるとみられている。また、3D XPointでは、カルコゲナイド材料と「Ovonyx」スイッチが使われていることが明らかになった。 ASMLがEUV装置を15台受注、納品先はIntel?
ASMLがEUV装置を15台受注、納品先はIntel?
ASMLが、EUV(極端紫外線)リソグラフィ装置を15台、“米国顧客企業の1社”に納入すると発表し、業界の観測筋の間でさまざまな臆測を呼んでいる。複数の情報筋が、この顧客企業がIntelではないかという見方を示している。 TSMCが5nmプロセス開発に着手
TSMCが5nmプロセス開発に着手
TSMCが5nmプロセスの開発に着手する。ただし、EUV(極端紫外線)リソグラフィを採用するかどうかは、まだ不明だ。とはいえ、193nm ArF液浸リソグラフィを適用するには、かなりの数のパターニングが必要になり、コストが膨れ上がる。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 2023年の世界半導体売上高ランキングトップ20、NVIDIAが初の2位に
- 中国政府の「Intel/AMD禁止令」、中国企業への強い追い風に
- 就業人員の4割が帰還組、ルネサス甲府工場が10年の時を経て再稼働
- JDI、次世代有機ELディスプレイ「eLEAP」を24年12月に量産開始へ
- 日本伝統の「和装柄」がヒントに 半導体の高度な熱管理につながる技術
- ルネサス甲府工場がいよいよ再稼働 柴田社長「パワー半導体の戦略的拠点に」
- Raspberry PiがAIカメラモジュール発売へ、ソニーのAI処理機能搭載センサー採用
- 半導体製造装置の販売額、2023年は1063億ドルで前年比1.3%減
- 全固体ナトリウム電池の量産化に向けた新合成プロセスを開発、大阪公立大
- Rapidus、シリコンバレーに新会社設立 AI半導体の顧客開拓を加速

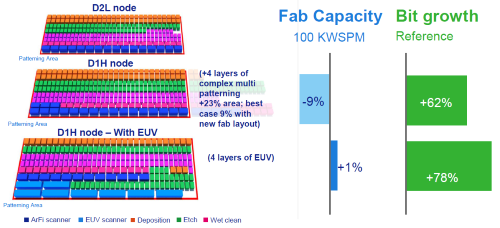 ASMLによれば、EUVリソグラフィを使えば、DRAM製造工場はスループットを向上できるとしている
ASMLによれば、EUVリソグラフィを使えば、DRAM製造工場はスループットを向上できるとしている