大阪大学、パワー半導体の3D配線が低コストに:銀粒子の焼結メカニズムを解明
大阪大学の菅沼克昭教授らは、独自に開発した銀粒子焼結技術を用い、次世代パワー半導体の3D配線を低コストで実現するための技術を開発した。
SiC/GaNパワー半導体の実用化に弾み
大阪大学産業科学研究所の菅沼克昭教授らによる研究グループは2017年1月、独自に開発した銀粒子焼結の技術を用い、次世代パワー半導体の3D配線を低コストで実現するための技術を開発したと発表した。
銀粒子焼結技術は、菅沼研究室が1983年に開発した、粉末を接合層とする異種材料接合技術である。銀粒子を用い、大気中において250℃の低温で接合できるという特長がある。このため、次世代パワー半導体の実装技術として注目され、欧州では実用化が始まっているという。ところが、融点(銀は962℃)より極めて低い温度で、銀粒子焼結が形成されるというメカニズムはこれまで明らかになっていなかった。
研究グループは今回、200℃程度で大気中の酸素と反応しながら、Ag-O液体噴火することで金属焼結が進むことを明らかにし、そのメカニズムが「ナノ噴火現象」であることを突き止めた。この現象は銀特有で、金や銅などほかの金属では不可能だという。
研究では、基板に実装されたSiC(炭化ケイ素)ダイの表面に、凹凸に応じた3D配線を印刷技術で形成し、大気中無加圧の雰囲気において250℃で焼成した。そうしたところ5×10-6Ωcmという低い抵抗値となった。
従来のワイヤーボンディングやリボンボンディングによる配線方法に比べて、新技術を用いると低温焼成で製造コストも安く、低ノイズ、低抵抗の3D配線が可能になるという。研究グループは、今回の研究成果によってSiC、GaN(窒化ガリウム)パワー半導体の高性能化と低コスト化を同時に実現でき、搭載した電力変換器のさらなる小型化や省エネ化につながるとみている。
Copyright © ITmedia, Inc. All Rights Reserved.
Special Contents
- PR -Special Contents
- PR -記事ランキング
- 半導体市場25年は予想以上に伸びるが26年はメモリが失速? ―― WSTS春季予測考察
- イメージセンサー金額シェア60%目標「数年遅れる」、ソニー半導体
- 微細化前倒しや3層積層の強化……「市場で勝ち切る」ソニーの半導体戦略
- 暗い夜道でも120m先の歩行者を検知、キヤノンが新SPADセンサー
- ソニーが「最速」のSPAD距離センサー開発、自動運転L3以上へ
- 自律神経から「頑張りすぎ」を可視化、村田製作所
- 自動運転のキーデバイスとなる車載SoC
- キオクシアが攻める「NANDとDRAMのあいだ」 NVIDIAと協業も
- 次はデータセンター 「スマホ以外」にも手を広げるQualcomm
- 商用化から40年を迎えたFPGA、次の主戦場はエッジAI


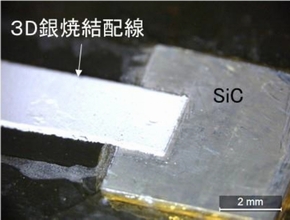
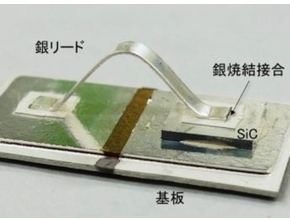 銀粒子焼結により形成した3D配線(左)と、従来のリボンボンディングによる配線(右)の画像 出典:大阪大学
銀粒子焼結により形成した3D配線(左)と、従来のリボンボンディングによる配線(右)の画像 出典:大阪大学 脳波の状態から自動で作曲を行うAI、大阪大学など
脳波の状態から自動で作曲を行うAI、大阪大学など SiCパワー半導体が300℃でも動作する基板構造
SiCパワー半導体が300℃でも動作する基板構造 パッチ式脳波センサー、脳の状態を簡便に測定
パッチ式脳波センサー、脳の状態を簡便に測定 LEDより高性能? 高輝度/小型の3原色レーザー光源
LEDより高性能? 高輝度/小型の3原色レーザー光源 新磁石を発見、ディラック電子の流れを制御
新磁石を発見、ディラック電子の流れを制御 シリコン産廃を燃料電池の水素供給源にする技術
シリコン産廃を燃料電池の水素供給源にする技術


