EE Times Japan >
プロセス技術 >
東芝、SiC-MOSFETの抵抗を下げる新プロセス開発:チャネル領域の抵抗を約4割減
東芝は2017年9月19日、SiC-MOSFETのチャネル領域の抵抗を約40%低減する新しいプロセス技術を開発したと発表した。
» 2017年09月20日 14時10分 公開
[竹本達哉,EE Times Japan]
窒素ガスを使用
東芝は2017年9月19日、SiC(炭化ケイ素)を用いたMOSFET(以下、SiC-MOSFET)のチャネル領域の抵抗を約4割低減する新たなゲート絶縁膜プロセスを開発したと発表した。このプロセス技術を用いることで、素子全体の抵抗を最大で20%低減できる見込みとし、SiC-MOSFETデバイス使用時の電力損失の低減が期待できるという。
開発したプロセス技術は、チャネル領域を形成するゲート絶縁膜プロセス。開発した技術は、同プロセスで一般に使用される酸化窒素(NO、N2O)ガスに代えて、取り扱いが容易な窒素(N2)ガスを使用するもの。
ゲート絶縁膜の母材となる二酸化ケイ素(SiO2)をN2ガスで焼鈍する直前に、900℃未満の低いプロセス温度で酸素雰囲気に暴露するなどの独自処理を施し、反応性に乏しいN2ガスであっても十分な窒化反応を起こし、抵抗が増大する要因となるチャネル領域周辺の欠陥を修復することに成功した。
その上で、開発したプロセス技術では、一般的なNOガスを用いた場合と比較して、ゲート絶縁膜の信頼性を損なうことなくチャネル領域の抵抗が約40%低減されることも確認したとする。
東芝では、2020年以降の実用化を目指し、信頼性の向上を図る研究開発を行っていく方針。
関連記事
 東芝、寝台列車「瑞風」に小型駆動システム納入
東芝、寝台列車「瑞風」に小型駆動システム納入
東芝は2017年6月16日、JR西日本の新型寝台列車「TWILIGHT EXPRESS 瑞風(みずかぜ)」向けに、小型ハイブリッド駆動システムを納入したと発表した。 TDKと東芝、車載インバーターの合弁会社を設立へ
TDKと東芝、車載インバーターの合弁会社を設立へ
TDKと東芝は、車載インバーター事業を手掛ける合弁会社「TDKオートモーティブテクノロジーズ株式会社」を設立することで合意した。事業開始は2016年12月1日を予定している。 SiC/GaNウエハーの欠陥解析装置――東陽テクニカ
SiC/GaNウエハーの欠陥解析装置――東陽テクニカ
東陽テクニカは、「イノベーション・ジャパン2016」(2016年8月25〜26日)で、「サブナノ結晶配向情報検出ウエハーマッピング装置」の開発成果を展示した。SiC(炭化ケイ素)やGaN(窒化ガリウム)ウエハー基板の量産化に貢献する品質・信頼性評価技術として期待される。 Infineon、フルSiCモジュールを2018年に量産へ
Infineon、フルSiCモジュールを2018年に量産へ
Infineon Technologiesは、ドイツ・ニュルンベルクで開催中のパワー半導体の展示会「PCIM Europe 2017」(2017年5月16〜18日)で、耐圧1200VのSiC-MOSFETと、それを搭載したフルSiCモジュールの量産について発表した。SiCだけでなくGaNでも新製品を発表している。 三菱電機がSiC-SBDを発売、ディスクリート品は初
三菱電機がSiC-SBDを発売、ディスクリート品は初
三菱電機は、SiC(炭化ケイ素)を用いたパワー半導体の新製品「SiC-SBD」を2017年3月1日に発売した。同社はこれまでSiC-SBDやSiC-MOSFETを搭載したパワー半導体モジュールを2010年から製品化してきたが、ディスクリート品の提供は初となる。 パワー半導体、シリコンの置き換えは何年も先
パワー半導体、シリコンの置き換えは何年も先
ドイツで開催されたパワーエレクトロニクスの展示会「PCIM Europe 2016」では、SiCとGaNを用いたパワー半導体が多く展示された。パワーエレクトロニクス業界に40年以上身を置く、ECPE(European Center for Power Electronics)のプレジデントを務めるLeo Lorenz氏に、現在のパワー半導体の動向について話を聞いた。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 重量はクジラ級! 超巨大な高NA EUV装置の設置をIntelが公開
- JDI、次世代有機ELディスプレイ「eLEAP」を24年12月に量産開始へ
- 2023年の世界半導体売上高ランキングトップ20、NVIDIAが初の2位に
- 中国政府の「Intel/AMD禁止令」、中国企業への強い追い風に
- パワー半導体向けウエハー市場、2035年に1兆円台へ
- Intelが高NA EUV装置の組み立てを完了、Intel 14Aからの導入に向けて前進
- 全固体ナトリウム電池の量産化に向けた新合成プロセスを開発、大阪公立大
- 「GPT-4」を上回る性能で、グラフィカルな文書を読解するLLM技術
- わずか3個のLSIでモバイル超音波診断装置を実現、ソシオネクスト
- TSMC、24年Q1は増収増益 地震の影響は「最小限にとどまる」


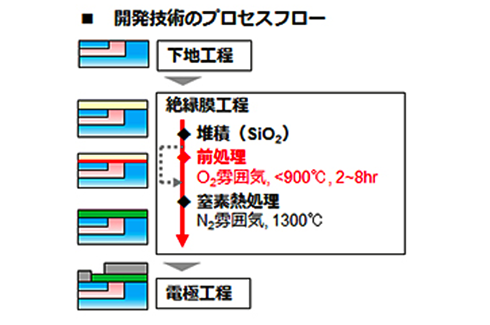 開発技術のプロセスフロー 出典:東芝
開発技術のプロセスフロー 出典:東芝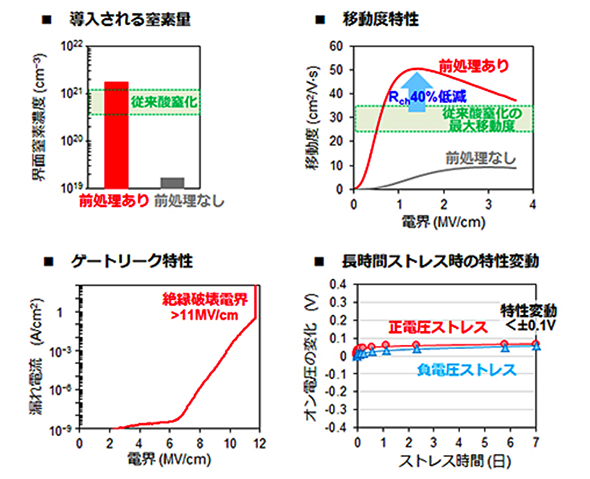 開発したプロセス技術の特性 出典:東芝
開発したプロセス技術の特性 出典:東芝