誰がドライエッチング技術を発明したのか:湯之上隆のナノフォーカス(2) ドライエッチング技術のイノベーション史(2)(2/5 ページ)
2-2)プラズマエッチングの可能性が拡大
SigneticsのIrvingらにプラズマ装置を提供したLFEでも、プラズマエッチングの重要な発明がなされた。
LFEのAdir Jacobは1971年8月20日に、“Process for Use in the Manufacture of Semiconductor Devices”という特許を出願する(US 3,806,365)。Jacobは、無機物の不純物も含めてレジストを全て除去するために酸素と少なくとも2種類の有機ハロゲン化物の混合ガスによるプラズマを使ったアッシングを発明した。そして、その装置は後に、バレル型アッシング装置と呼ばれるようになり、広く普及した(図3)。
さらに、Jacobは1972年5月12日に、“Process and Material for Manufacturing Semiconductor Devices”という特許を出願した(US 3,795,557)。この特許でJacobは、Siとその化合物の他にMo、W、Taなど幅広い材料をエッチングできることを示した。
つまり、Jacobは、ダイシングを目指したIrvingらのプラズマエッチングの着想を、半導体の微細パタンの形成に展開できる契機をつくったといえる。
2-3)SiO2の選択エッチングの実現
ここまで、Bersinが発明したLFEのプラズマ装置を用いて、SigneticsのIrvingらが酸素にハロゲンガスを添加したプラズマを使えばSiやAlがエッチングでいることを思い付き、LFEのJacobが、Si、その化合物、各種メタルなどをエッチングできることを示した。
しかし、半導体のプロセスにおいては、コンタクトホール開孔など、SiO2を高速にエッチングしたい工程があるが、そのプラズマエッチング技術が無かった。それを解決したのが、英国International Telephone and Telegraph(ITT)のRudolf A.H. Heineckeである。Heineckeは1973年5月17日(米国1974年5月3日)に、“Selective Plasma Etching and Deposition”という特許を出願した(US 3,940,506)。
CF4などに酸素を添加したプラズマでは、エッチング速度は、Si>SiN>SiO2の順となる。ここで、Heineckeは、CF4に酸素ではなく、水素やアンモニアなどの還元性のガスを添加したプラズマを用いて、SiやSiNよりも、SiO2が高速にエッチングできる技術を発明した。
Heineckeは、いかにして還元性ガスの添加を思い付いたのだろうか。筆者らは以下のように想像する。CF4と酸素の混合ガスプラズマにおけるエッチング速度は、Si>SiN>SiO2の順である。エッチング速度比の逆転が目的だから、「酸素と逆の還元性ガス、つまり水素」と発想したのではないだろうか。
いずれにせよHeineckeの発明により、バレル型プラズマエッチング装置を用いて、集積回路で使用するほとんどの材料を必要な選択比でエッチングできるようになった。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 重量はクジラ級! 超巨大な高NA EUV装置の設置をIntelが公開
- JDI、次世代有機ELディスプレイ「eLEAP」を24年12月に量産開始へ
- 2023年の世界半導体売上高ランキングトップ20、NVIDIAが初の2位に
- 中国政府の「Intel/AMD禁止令」、中国企業への強い追い風に
- パワー半導体向けウエハー市場、2035年に1兆円台へ
- 「GPT-4」を上回る性能で、グラフィカルな文書を読解するLLM技術
- Intelが高NA EUV装置の組み立てを完了、Intel 14Aからの導入に向けて前進
- 全固体ナトリウム電池の量産化に向けた新合成プロセスを開発、大阪公立大
- どうする? EVバッテリー リサイクルは難しい、でもリユースにも疑問
- TSMC、24年Q1は増収増益 地震の影響は「最小限にとどまる」

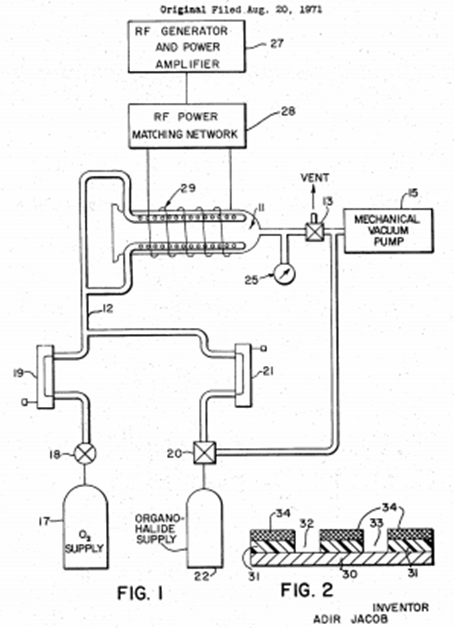 図3:LFEのJacobが発明したバレル型アッシング装置
図3:LFEのJacobが発明したバレル型アッシング装置