自動車用エレクトロニクスの放熱構造:福田昭のデバイス通信(204) 2019年度版実装技術ロードマップ(15)
今回から、ロードマップ第2章第5節「新技術・新材料・新市場」を取り上げる。まずは、5節の最初の項目である「サーマルマネジメント」から紹介していこう。
「新技術・新材料・新市場」が扱う3つのテーマ
電子情報技術産業協会(JEITA)が2019年6月に発行した「2019年度版 実装技術ロードマップ」の完成報告会(2019年6月4日に東京で開催)と同ロードマップの概要をシリーズでご報告している。今回はその第15回である。前回までは、ロードマップ本体の第2章第4節に当たる「モビリティー」の概要をご紹介した。今回から、ロードマップ本体の第2章第5節に当たる「新技術・新材料・新市場」の説明に入る。
 2019年6月4日に東京で開催された「2019年度版 実装技術ロードマップ」完成報告会のプログラム。今回から第2章「注目される市場と企業群」の第5節「新技術・新材料・新市場」(プログラムの6番)を説明していく。出典:JEITA(クリックで拡大)
2019年6月4日に東京で開催された「2019年度版 実装技術ロードマップ」完成報告会のプログラム。今回から第2章「注目される市場と企業群」の第5節「新技術・新材料・新市場」(プログラムの6番)を説明していく。出典:JEITA(クリックで拡大)この第5節には、大別すると3つの項目がある。「2.5.1 サーマルマネジメント(熱管理)」と「2.5.2 次世代ディスプレイ~マイクロLED~」「2.5.3 次世代通信 5G」である。「2.5.1 サーマルマネジメント」はさらに、「2.5.1.1 サーマルマネジメント技術」と「2.5.1.2 パワーモジュールにおける放熱技術と材料の動向」「2.5.1.3 携帯機器における放熱技術と材料の動向」の3つのパートに分かれている。
発熱部品から金属筐体やヒートシンクなどに熱を逃がす
ここからは、最初のテーマである「2.5.1 サーマルマネジメント(熱管理)」の始めの部分 「2.5.1.1 サーマルマネジメント技術(熱管理技術)」の概要を説明していく。この部分では、主に自動車エレクトロニクス(車載用電子製品)の放熱技術を扱う。
電子回路基板では、発熱部品(パワーデバイスやマイクロプロセッサなど)の熱を金属の筐体から周囲に逃がすことが多い。高い効率で熱を逃がすためには、発熱部品と金属筐体の距離を近づけることを基本とする。部品が発生する熱は、まず回路基板に伝わる。回路基板の両面を金属筐体で挟み込むことにより、回路基板の熱を金属筐体へと効率良く逃がす。回路基板の熱伝導率を高めるために、基板の銅箔層(配線層)の厚みを拡大することも実施されている。
発熱部品がパワーデバイスだけのときは、上記の手法による放熱が一般的である。しかしパワーデバイスと高発熱のマイクロプロセッサを混載した回路基板では、発熱部品のレイアウトが難しくなってしまう。そこで、発熱部品に「サーマルインタフェースマテリアル(TIM:Thermal Interface Material)」(熱界面材料)を装着し、TIMを介して金属筐体やヒートシンクなどに熱を伝える構造が採用されている。
ただし、ヒートシンクと発熱部品の表面にはいずれも凹凸があるので、両者の接触は面ではなく、点の集まりとなりやすい。つまり熱抵抗が高い。この隙間を埋めて熱抵抗を下げるためにTIMが使われる。このためTIMには、薄くて両者の表面形状(凹凸)に追従する柔らかい材料が求められる。
(次回に続く)
⇒「福田昭のデバイス通信」連載バックナンバー一覧
Copyright © ITmedia, Inc. All Rights Reserved.
Special Contents
- PR -Special Contents 1
- PR -記事ランキング
- ついにできた!Rapidus試作ライン稼働、2nm GAAトランジスタの動作を確認
- 中国の巨大市場を無視できず 米がAIチップ規制強化を撤回
- GaN撤退のTSMC、その後の戦略を考察する
- ペロブスカイト太陽電池、2040年に約4兆円規模へ
- パワー半導体受託生産のJSファンダリが破産申請、負債総額約161億円
- 新JFETやSuper Junction品投入へ、InfineonのSiC戦略
- 「ニコン初」後工程向け露光装置の概要を公開 L/S 1μmで50パネル/時
- 二極化した半導体市場――日本はどうするべきか?
- 中国の台頭、ファウンドリー顧客開拓……JSファンダリに見る半導体業界の課題
- 超小型部品の欠陥をAIで検出、1分間で2000個を検査



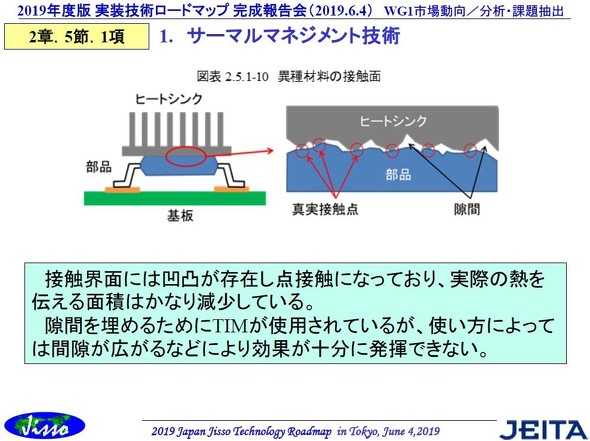
 SiCパワーデバイスがモビリティの電動化を加速
SiCパワーデバイスがモビリティの電動化を加速 鉄道と航空機の電動化
鉄道と航空機の電動化 電動化した自動車の種類と構造
電動化した自動車の種類と構造 HDD大手WDとSeagateの2019会計年度業績はいずれも減収減益に
HDD大手WDとSeagateの2019会計年度業績はいずれも減収減益に