1nmが見えてきたスケーリング 「VLSI 2020」リポート:湯之上隆のナノフォーカス(27)(6/7 ページ)
3D ICの加速
スローダウンしながらも、微細化は続いており、今回のVLSIシンポジウムでは、2〜1nmのトランジスタ構造が示された。また、その微細加工のために、EUV露光装置が量産適用され、ASMLはフル稼働でEUVを製造し出荷している。
しかし、最先端のシステムや電子機器からの要求はもっと大きく、微細加工を進めながら(More Moore)、それ以上にトランジスタの集積を要求している(More than Moore)。そして、後者のために、さまざまな半導体チップを積層する3D ICの技術が進化している(図21)。
 図21:3次元のチップ積層の進化 出典:Eric Beyne, imec, “Heterogeneous System Partitioning and the 3D Interconnect Technology Landscape”, VLSI 2020, SC2.2(クリックで拡大)
図21:3次元のチップ積層の進化 出典:Eric Beyne, imec, “Heterogeneous System Partitioning and the 3D Interconnect Technology Landscape”, VLSI 2020, SC2.2(クリックで拡大)パッケージを積層したり、インターポーザを介してチップを並べたりするSiP(System in Package)の次に、マイクロバンプを介してチップを積層する3D SICが登場し、チップを作り込んだウエハーとウエハーを直接ボンディングする3D SOCが実現した。そして、トランジスタをスタックする3D ICが開発されている。
例えば図22では、3D SOCとして、キャッシュメモリとコアになるロジック半導体をマイクロTSV(Through-Silicon Via)でつなぎ、さらに、異なるロジック半導体をボンディングでつないでいる。
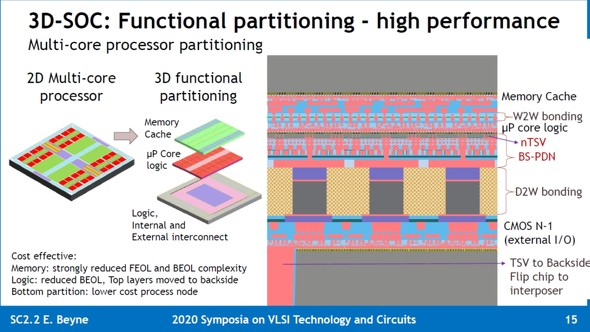 図22:3D ICの構造 出典:Eric Beyne, imec, “Heterogeneous System Partitioning and the 3D Interconnect Technology Landscape”, VLSI 2020, SC2.2(クリックで拡大)
図22:3D ICの構造 出典:Eric Beyne, imec, “Heterogeneous System Partitioning and the 3D Interconnect Technology Landscape”, VLSI 2020, SC2.2(クリックで拡大)もしこれを1チップで製造しようとすると、ロジック半導体とメモリを含んだマスクセットを用意し、べらぼうに長いプロセスフローを構築しなくてはならないだろう。一方、異種半導体をスタックできるのなら、ロジックはロジック、メモリはメモリに特化して製造し、それぞれの良品を接合すればよいことになる。3D SOCを設計するときに、全体最適化(Design Technology Co-Optimization、DECO)が必要になるが、プロセスコストやTAT(Turn Around Time)は、間違いなく3D SOCの方が有利だろう。
TSMCが開発した3D IC
TSMCが開発したImmersion in Memory Compute(ImMC)という3D ICの技術(略してSoICTM)は、コストだけでなく、パフォーマンスも抜群に優れている。
メモリとロジック半導体の一般的な3D IC(F2F:Face to Face)に対して、ベストな3D ICの“SoIC(F2F)”は、バンプ密度が16倍、スピードが11.9倍、バンド幅密度が191倍、1ビット当たりの消費電力は何と0.05倍になるのである(図23)。
 図23:TSMCのSoICTMの効果 出典:C.T. Wang, TSMC, “Immersion in Memory Compute (ImMC) Technology”, VLSI 2020, TH1.5
図23:TSMCのSoICTMの効果 出典:C.T. Wang, TSMC, “Immersion in Memory Compute (ImMC) Technology”, VLSI 2020, TH1.5さらに、プロセッサ2個、メモリ2個を、3次元的に接続する場合、どのような積層方法がベスト化を考えてみよう(図24)。ベストパフォーマンスを求めるなら、なるべく電子の移動距離を小さくするように設計するべきである。このように、システムの最適化を考えて設計することを、System Technology Co-Optimization(STCO)と呼ぶ。
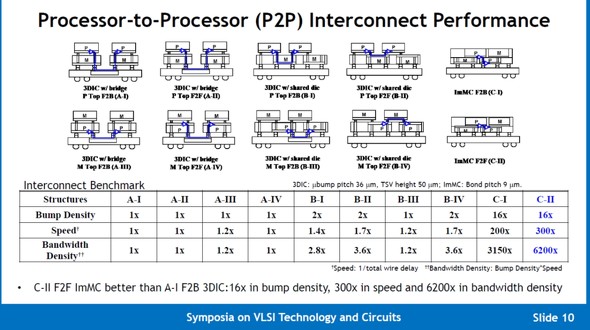 図24:プロセッサとプロセッサの接続のパフォーマンス 出典:C.T. Wang, TSMC, “Immersion in Memory Compute (ImMC) Technology”, VLSI 2020, TH1.5(クリックで拡大)
図24:プロセッサとプロセッサの接続のパフォーマンス 出典:C.T. Wang, TSMC, “Immersion in Memory Compute (ImMC) Technology”, VLSI 2020, TH1.5(クリックで拡大)A-I構造を基準として、最も電子の移動距離が小さなC-II構造を採用した場合、バンプ密度は16倍になり、スピードは300倍、バンド幅密度が6200倍にもなる。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 重量はクジラ級! 超巨大な高NA EUV装置の設置をIntelが公開
- JDI、次世代有機ELディスプレイ「eLEAP」を24年12月に量産開始へ
- 2023年の世界半導体売上高ランキングトップ20、NVIDIAが初の2位に
- 中国政府の「Intel/AMD禁止令」、中国企業への強い追い風に
- パワー半導体向けウエハー市場、2035年に1兆円台へ
- 「GPT-4」を上回る性能で、グラフィカルな文書を読解するLLM技術
- Intelが高NA EUV装置の組み立てを完了、Intel 14Aからの導入に向けて前進
- どうする? EVバッテリー リサイクルは難しい、でもリユースにも疑問
- 全固体ナトリウム電池の量産化に向けた新合成プロセスを開発、大阪公立大
- TSMC、24年Q1は増収増益 地震の影響は「最小限にとどまる」
