ムーアの法則 次なるけん引役は「チップレット」 〜IEDM2020に見る先端パッケージ技術:湯之上隆のナノフォーカス(35)(5/6 ページ)
HBM(High Bandwidth Memory)で高速化
図13に、GDDR5という規格のDRAMを周辺に配置したレガシーなSoCと、GDDR5をTSVでつないで縦に積層したHBM(High Bandwidth Memory)を周辺に配置したSoCの比較を示す。HBMを利用することにより、縦が1.6倍、横が2倍、面積が3倍、それぞれ縮小される。つまり、DRAMとSoCの合計のフットプリントを3分の1にできる。これもチップレットをうまく適用した例と言える。
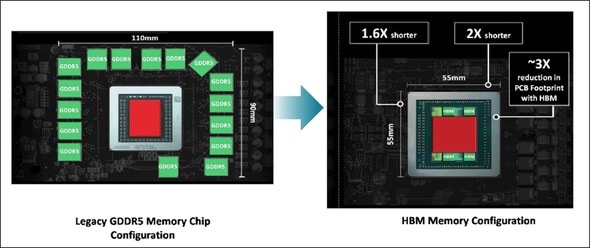 図13:HBM(High Bandwidth Memory)を配置したSoC 出典:Greg Yeric, arm community, “Three Dimensions in 3DIC - Part I”, April 2, 2018(クリックで拡大)
図13:HBM(High Bandwidth Memory)を配置したSoC 出典:Greg Yeric, arm community, “Three Dimensions in 3DIC - Part I”, April 2, 2018(クリックで拡大)図14は、HBM(High Bandwidth Memory)を配置したSoCの断面模式図を示す。TSVで縦につながったDRAMがロジックチップとインターポーザを介して、SoCに接続している。高速処理を必要とするSoCのすぐ隣にHBMが配置されることにより、データの転送が極めて高速になるメリットを生む。
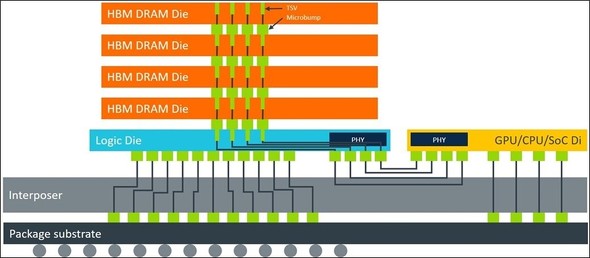 図14:HBM(High Bandwidth Memory)を配置したSoCの断面模式図 出典:Greg Yeric, arm community, “Three Dimensions in 3DIC - Part I”, April 2, 2018(クリックで拡大)
図14:HBM(High Bandwidth Memory)を配置したSoCの断面模式図 出典:Greg Yeric, arm community, “Three Dimensions in 3DIC - Part I”, April 2, 2018(クリックで拡大)図15は、GDDR5とHBMのBus Width、Clock Speed、Bandwidth、動作Voltageを比較した表である。Bus Widthは、GDDR5が32ビットであるのに対して、HBMは32倍の1024ビットになる。その結果、クロック速度がGDDR5の1750MHzより遅い500MHzであるにもかかわらず、BandwidthがGDDR5の1チップ当たり25GB/sに対して、HBMの1ブロックが100GB/sと4倍以上のバンド幅になる。
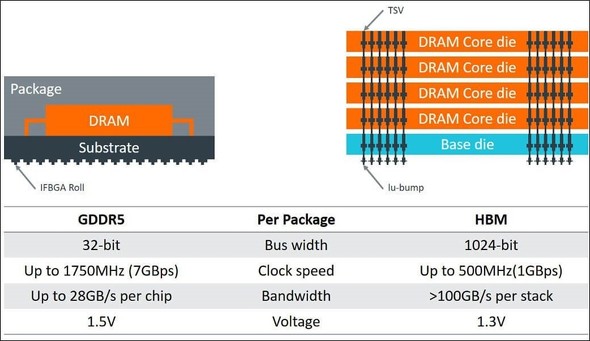 図15:HBM(High Bandwidth Memory)のバンド幅の大きさ 出典:Greg Yeric, arm community, “Three Dimensions in 3DIC - Part I”, April 2, 2018(クリックで拡大)
図15:HBM(High Bandwidth Memory)のバンド幅の大きさ 出典:Greg Yeric, arm community, “Three Dimensions in 3DIC - Part I”, April 2, 2018(クリックで拡大)要するに、GDDR5が1個の場合は、片側1車線の道路をトラックが高速で突っ走っているようなものであり、道が1本しかないので運べるデータ量が限られるのに対して、HBMの場合は4車線の高速道路を4台のトラックで悠々走ることができるため、一度に運べるデータ量が圧倒的に多くなるというわけである。
このHBMを使って、チップレットをうまく適用すれば、SoCのAIを高速に動作することが可能になるのである。やっと、チップレットとは何か、そのメリットは何かを説明することができた。さて、IEDMでは、Intel、Samsung、TSMCが、どのような発表を行ったのだろうか?
IEDMでのIntelとSamsungの先端パッケージの発表
IntelのRavi Mahajan氏がTutorialの“Advanced Packaging Technologies for Heterogeneous Integration(HI)”にて、先端パッケージの発表を行った(図16)。Embedded Multi-Die Interconnect Bridge(EMIB)では、プロセッサコアを分割して製造した後に、インターポーザを介してインテグレーションしてチップを形成している。また、Foverosでは、TSVで異なるチップを積層して1チップ化している。さらに、EMIBとFoverosを組み合わせたCo-EMIBを実現している。
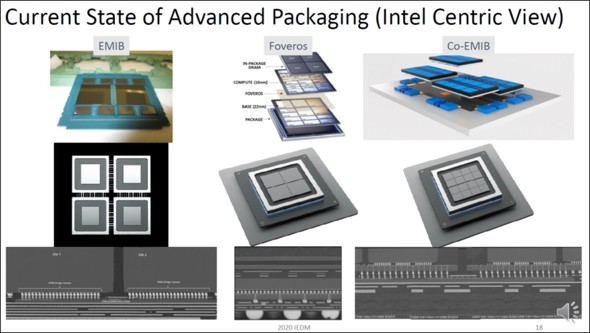 図16:Intelの3次元パッケージ(EMIB、Foveros、Co-EMIB) 出典:Ravi Mahajan (Intel), “Advanced Packaging Technologies for Heterogeneous Integration (HI)”, IEDM2020, Tutorial2.(クリックで拡大)
図16:Intelの3次元パッケージ(EMIB、Foveros、Co-EMIB) 出典:Ravi Mahajan (Intel), “Advanced Packaging Technologies for Heterogeneous Integration (HI)”, IEDM2020, Tutorial2.(クリックで拡大)次に、SamsungのSE-Ho You氏が、Short Courseの“From Package-Level to Wafer-Level Integration”にて発表したスライドを図17に示す。X-Cubeとは、異なるチップをTSVで積層するチップレットを意味する。IntelのFoverosに相当すると言える。また、異なるチップを、インターポーザを介して接続するI-Cubeは、IntelのEMIBと似ている。さらに、X-Cube とI-Cube を組み合わせたX/I-Cubeは、IntelのCo-EMIBと非常に良く似ている。
IntelとSamsungのどちらが早く上記を開発したか筆者は知らないが、両者とも、非常に良く似た先端パッケージ技術を開発していると言えるだろう。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 重量はクジラ級! 超巨大な高NA EUV装置の設置をIntelが公開
- どうする? EVバッテリー リサイクルは難しい、でもリユースにも疑問
- パワー半導体向けウエハー市場、2035年に1兆円台へ
- 「GPT-4」を上回る性能で、グラフィカルな文書を読解するLLM技術
- 2023年の世界半導体売上高ランキングトップ20、NVIDIAが初の2位に
- Intelが高NA EUV装置の組み立てを完了、Intel 14Aからの導入に向けて前進
- 中国政府の「Intel/AMD禁止令」、中国企業への強い追い風に
- JDI、次世代有機ELディスプレイ「eLEAP」を24年12月に量産開始へ
- Intelの最新AI戦略と製品 「AIが全てのタスクを引き継ぐ時代へ」
- TSMC、24年Q1は増収増益 地震の影響は「最小限にとどまる」