「SEMICON West 2016」、7nm世代以降のリソグラフィ技術(ニコン編):福田昭のデバイス通信(86)(2/2 ページ)
マルチパターニングと新たなリソグラフィ技術の組み合わせへ
露光技術(ソフトウェア)による解像度の向上は、露光回数を増やすマルチパターニング技術によって成し遂げられている。露光回数をn回とすると、ケイワンファクタ(K1)は原理的にはK1/nに減る。例えば、もともとのK1が0.30のリソグラフィにダブルパターニング(n=2)を導入すると、K1は0.15になる。先ほどのレイリーの式に当てはめると、解像力は22nmと大きく向上する。
もちろん、代償は存在する。ダブルパターニングを導入すると、スループットがガタ落ちになってしまう。スループットの低下は製造コストの上昇を意味する。コストの上昇を吸収可能な販売価格のシリコンダイであることが、ダブルパターニング採用の前提である。
コスト増だと分かりつつも、マルチパターニング技術は導入せざるを得ない。Renwick氏が示したスライドによると、10nm世代向けのArF液浸スキャナー「NSR-S630D」では、ダブルパターニング技術を駆使することによってフィン幅が10nm、フィンピッチが30nmのフィンFETを製造可能だとする。
しかし、7nm世代向けのArF液浸スキャナー「NSR-631E」になると、クオドパターニング(4回露光)技術の採用だけでなく、補完的に新しいリソグラフィ技術を導入していくことになると予測する。新しいリソグラフィ技術の候補は、「誘導自己組織化(DSA:Directed Self-Assembly)」「電子ビーム直接描画(Electron Beam Direct Writing)」「EUV(極端紫外線)リソグラフィ」の3つである。
電子ビーム直接描画とArF液浸の組み合わせがコストで有利
新しいリソグラフィ技術の導入によってコストはどのように変わるだろうか。ArF液浸のダブルパターニング、EUVリソグラフィ、電子ビーム直接描画を候補として比較してみせた。すると、ArF液浸のダブルパターニングと電子ビーム直接描画の組み合わせが最も低いという結果が出た。電子ビーム装置の減価償却費が加わっての計算だけに、この結果は興味深い。
 リソグラフィ技術の組み合わせによるコストの違い。コストの内訳は、「Depr」が装置の減価償却費、「Other」がその他、「Floor」が床材(耐重量を上げるためのコストと思われる)、「Labor」が作業員の人件費、「Util」はユティリティ(電気料金など)、「Cons」は建築費用、「Chem」は化学薬品(レジストを含む)、「Mask」はマスク費用。内訳では装置の減価償却費が最も大きく、次がマスク費用であることが分かる(クリックで拡大) 出典:Nikon Research Corporation of Americaの講演スライドから
リソグラフィ技術の組み合わせによるコストの違い。コストの内訳は、「Depr」が装置の減価償却費、「Other」がその他、「Floor」が床材(耐重量を上げるためのコストと思われる)、「Labor」が作業員の人件費、「Util」はユティリティ(電気料金など)、「Cons」は建築費用、「Chem」は化学薬品(レジストを含む)、「Mask」はマスク費用。内訳では装置の減価償却費が最も大きく、次がマスク費用であることが分かる(クリックで拡大) 出典:Nikon Research Corporation of Americaの講演スライドからこのほか講演では、20nm×10nmの長方形のパターンを例に、ArF液浸とEUVリソグラフィ、電子ビーム直接描画のそれぞれについてパターン形状の乱れを計算した結果を示していた。パターン形状の乱れはArF液浸が最も小さく、電子ビーム直接描画が最も大きかった。EUVリソグラフィと電子ビーム直接描画を現時点では補完技術と考えていることがうかがえた。
(次回に続く)
⇒「福田昭のデバイス通信」バックナンバー一覧
関連記事
Copyright © ITmedia, Inc. All Rights Reserved.
Special Contents
- PR -Special Contents
- PR -Special Contents 1
- PR -記事ランキング
- 半導体市場25年は予想以上に伸びるが26年はメモリが失速? ―― WSTS春季予測考察
- イメージセンサー金額シェア60%目標「数年遅れる」、ソニー半導体
- DRAM業界をかき乱す中国勢、DDR4の供給の行方は?
- 微細化前倒しや3層積層の強化……「市場で勝ち切る」ソニーの半導体戦略
- 暗い夜道でも120m先の歩行者を検知、キヤノンが新SPADセンサー
- 自律神経から「頑張りすぎ」を可視化、村田製作所
- ソニーが「最速」のSPAD距離センサー開発、自動運転L3以上へ
- 自動運転のキーデバイスとなる車載SoC
- キオクシアが攻める「NANDとDRAMのあいだ」 NVIDIAと協業も
- 次はデータセンター 「スマホ以外」にも手を広げるQualcomm


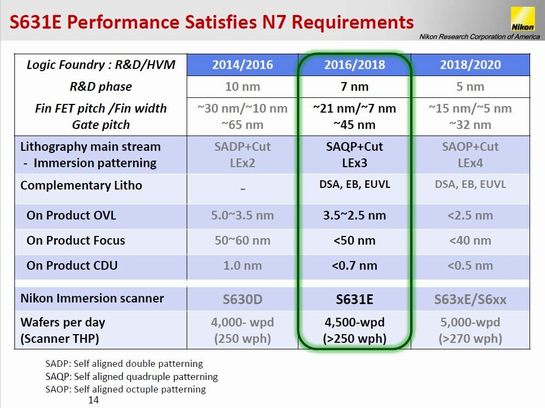
 ニコンが展望する10nm以下のリソグラフィ技術(前編)
ニコンが展望する10nm以下のリソグラフィ技術(前編) 2020年、5nm世代でEUV時代が到来か
2020年、5nm世代でEUV時代が到来か TSMCが5nmプロセス開発に着手
TSMCが5nmプロセス開発に着手 ムーアの法則、実質的には28nmが最後か
ムーアの法則、実質的には28nmが最後か EUVは、微細化の“万能策”ではない
EUVは、微細化の“万能策”ではない 反転層型ダイヤモンドMOSFETの動作実証に成功
反転層型ダイヤモンドMOSFETの動作実証に成功




