進む7nmプロセスの開発、TSMCとIBMが成果を発表:IEDM 2016(1/2 ページ)
米サンフランシスコで開催された「IEDM 2016」では、TSMCとIBMがそれぞれ最新プロセス技術について発表し、会場を大いに沸かせたようだ。
TSMCとIBMの発表に沸いたIEDM
TSMCとIBMは、米国カリフォルニア州サンフランシスコで2016年12月3~7日に開催された、最先端電子デバイスの研究開発に関する国際学会「IEDM 2016」の初日に、それぞれ7nmプロセス技術に関する論文を発表した。大勢の来場者でにぎわう会場は、まるでクリスマスプレゼントのようなこの発表を受け、大いに活気付いた。両社の論文は、ムーアの法則とEUV(極端紫外線)リソグラフィの両方を前進させる開発成果を明らかにしている。
TSMCは、業界最小となる6T(6トランジスタ) SRAMを開発し、2017年4月までにはリスク生産を開始する予定だという。またIBMは、EUVを適用した研究装置を使用して、業界最小のFinFETを実現したと発表している。
会議の主催者は2016年10月に、これらの論文を、IEDM 2016に関する最新ニュースの見出しとして取り上げている。にもかかわらず、両社は今回、予想をはるかに上回る素晴らしい成果を挙げ、会場を驚かせた。
IBMは、CPP(Contacted Poly Pitch)が44/48nm、金属ピッチが36nm、フィンピッチが27nmのFinFETを発表した。また、ソース・ドレインのコンタクト開口が約10nm、ゲート長が約15nmのデバイスもあるという。
TSMCが発表した256MビットのSRAMテストチップは、セル密度が0.027mm2で、読み出し/書き込み電圧を0.5Vに低減するという。TSMCでN7開発担当シニアディレクターを務めるMichael Shien-Yang Wu氏は、「当社が現在量産を進めている16FF+プロセス技術と比べて、最大40%の高速化と、65%の低消費電力化、3.3倍のルートゲート密度を実現することができる」と述べている。
またWu氏は、7nmプロセスを適用してEUVの有効性を実証する取り組みについても説明しているが、これに関しては、同氏が今回正式に発表した論文の中には記されていない。次世代リソグラフィは、既存の液浸ステッパーに匹敵するフィデリティー(忠実度)と歩留まりを実現することが可能なため、同社は2017年に実用化する予定の7nmプロセスで採用する予定だという。
ASMLのEUV装置は、現在も生産開始前の試作段階にある。TSMCは既に、5nmプロセスでEUVを使用する予定であることを発表している。
Wu氏は、TSMCの7nmプロセスが、同社の10nmプロセスや、Samsung Electronics(サムスン電子)などのライバル企業のプロセス技術と比較してどのように異なるかについては、詳細を明らかにしなかった。また同氏は、TSMCの7nm FinFETのアスペクト比や、7nmプロセスで使用する最新の歪み技術についても詳細な説明は避け、GPUやARMの「Cortex A-72」コアを搭載するテストチップの歩留まりの数値が2桁であることのみを明かすにとどめた。
PC関連技術の記事やホワイトペーパーの発信を手掛ける米国のReal World TechnologiesのアナリストであるDavid Kanter氏は、「TSMCの論文には、7nmプロセスでサポート可能な電圧範囲に関する記述がない。また、エアギャップをサポートしているかどうかを示す顕微鏡写真が、1枚も掲載されていない」と指摘する。
Kanter氏は、「Wu氏が、『7nm SRAMの歩留まりが50%に達した』と述べていることから、2017年後半には量産を開始する予定だとみている」と述べた。
Copyright © ITmedia, Inc. All Rights Reserved.
Special Contents
- PR -Special Contents
- PR -記事ランキング
- 半導体市場25年は予想以上に伸びるが26年はメモリが失速? ―― WSTS春季予測考察
- イメージセンサー金額シェア60%目標「数年遅れる」、ソニー半導体
- 自律神経から「頑張りすぎ」を可視化、村田製作所
- ソニーが「最速」のSPAD距離センサー開発、自動運転L3以上へ
- 暗い夜道でも120m先の歩行者を検知、キヤノンが新SPADセンサー
- 商用化から40年を迎えたFPGA、次の主戦場はエッジAI
- 微細化前倒しや3層積層の強化……「市場で勝ち切る」ソニーの半導体戦略
- JDIの液晶の知見、先端半導体パッケージングの中核技術に
- 「NVIDIAと真逆の取り組みをしよう」 Jim Keller氏
- 自動運転のキーデバイスとなる車載SoC

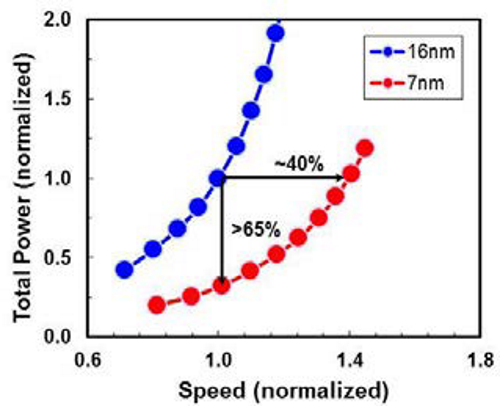 TSMCは、同社の「16FF+」プロセスと7nmプロセスの比較結果を発表した 出典:IEDM
TSMCは、同社の「16FF+」プロセスと7nmプロセスの比較結果を発表した 出典:IEDM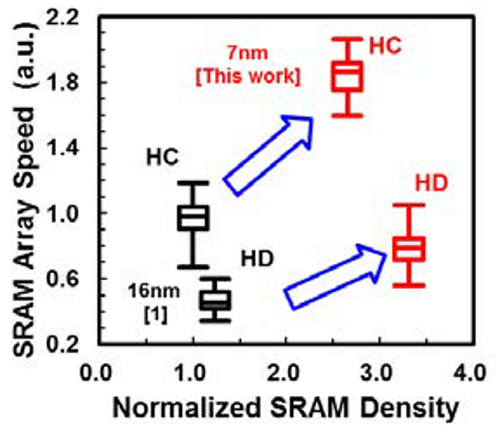 TSMCの7nm SRAMの記憶密度は新しい次元に達した 出典:IEDM
TSMCの7nm SRAMの記憶密度は新しい次元に達した 出典:IEDM


