熱圧着プロセスを10分の1に短縮、新しい実装技術:日立化成が提案
日立化成は「SEMICON Japan 2017」(2017年12月13~15日、東京ビッグサイト)で、TCB(Thermal Compression Bonding:熱圧着)プロセスにかかる時間を最大10分の1に短縮する実装技術を提案した。
TCBプロセスの時間を短縮
日立化成は、東京ビッグサイトで開催中の「SEMICON Japan 2017」(2017年12月13~15日)で、TCB(Thermal Compression Bonding:熱圧着)プロセスにかかる時間を短縮する実装技術を提案した。
現状のTCBプロセスは、位置合わせ、熱圧着、冷却というステップで行われているが、チップを1個ずつ圧着している上に、処理時間が長いので、全体としてかなり時間がかかる工程になっている。日立化成によれば、処理時間の平均は1チップ当たり約20秒だという。
そこで日立化成は、まず複数のチップをまとめて熱圧着する方法を提案した。同社が開発した「BFL(Bonding Force Leveling)フィルム」を熱圧着ヘッドとチップの間に挟む。BFLフィルムは柔らかく、わずかに存在しているチップ高さのばらつきを吸収する。そのため、幾つかのチップを一気に圧着しても、高さのばらつきによってボンディングされていないチップが発生することがないという。この方法により、処理時間は1チップ当たり約3秒と、従来の方法に比べて6分の1以下になるとする。
2つ目の方法は、“熱圧着そのものをなくす”というものだ。こちらは、メモリチップをTSV(Through Silicon Via)で積層するような、3D(3次元)実装への適用を想定している。NCF(Non Conductive Film)をラミネートした上にチップを積層して仮搭載した後、一気にモールドして全体を形成し、その後のリフロー処理でチップ間のはんだ接続を行う。1つずつリフロー処理を行う必要はない。実装時間(仮搭載の処理)は1チップ当たり約2秒と、従来の10分の1になる。日立化成は、NFCとモールド樹脂を開発している。
日立化成は、5面保護封止をする場合の新実装技術も展示した。従来は、ダイシングした後にチップを1つずつ再配置し、オーバーモールドを行い、切断する。最も時間がかかるのが再配置で、日立化成によれば、チップ1000個で約30分かかるという。そこで同社は、「ダイ・ギャップ・エクスパンディング・フィルム」を開発した。伸ばすことができる基板フィルムである。ダイシングした後にこのフィルムを引き伸ばすことで、チップとチップの間隔が広がるので、チップを再配置する必要がなくなる。あとは、間隔が空いたチップをフィルムごとひっくり返してキャリアに一括転写し、フィルムをはがしてオーバーモールドする。これにより、フィルムの引き伸ばしから転写処理まで、わずか数分で完了するという。
これらの実装技術はいずれも開発中で、日立化成は、実用化のメドについては明らかにしなかった。
Copyright © ITmedia, Inc. All Rights Reserved.
Special Contents
- PR -- 郢ァ�「郢晏干ホ懃ケァ�ア郢晢スシ郢ァ�キ郢晢スァ郢晢スウ邵コ�ョ髫補或�サ�カ邵コ�ォ陟「諛環ァ邵イ竏壹☆郢ァ�ー郢晉ソォホ晉ケ昶�縺臥ケ晢スシ郢晢スウ邵コ�ョ雎ク驛�スイ�サ鬮ョ�サ陷牙ク呻ス定恆鬆托スク蟶吮�郢ァ蛹コ蟀ソ雎包ソス
- 闖エ蜿厄スカ驛�スイ�サ鬮ョ�サ陷牙ケ「�シ蝓趣スォ蛟。�イ�セ陟趣スヲ邵コ�ョ郢ァ�キ郢ァ�ー郢晉ソォホ晉ケ昶�縺臥ケ晢スシ郢晢スウ邵イ竏オ�ウ�ィ隲「荳奇ス定ャ�シ披鴬邵コ�ケ邵コ髦ェ縺。郢ァ�、郢晄コ佩ヲ郢ァ�ー髫補�螻冗クコ�ィ邵コ�ッ�ス�ス
- 隴幢スャ霑夲スゥ邵コ�ィ髫募唱�ス邵コ莉」窶イ邵コ�、邵コ荵昶�邵コ�ス�キ�ァ陞ッ蜷カ竊題屁�ス鬨セ�ス陷企宦�ー諠ケ�ス讌「�」�ス陷ゥ竏堋竏ス�シ竏オ�・�ュ邵コ迹夲スェ�ソ鬩墓鱒縲定ア悟干�定脂蛟・��郢ァ荵晢シ�クコ�ィ邵コ�ッ�ス�ス
- [EE Times Japan驍ア�ィ鬮ョ�スホ咯 Intel邵イ竏ス�サ鄙ォ竊千クコ�ス竊醍クコ�」邵コ�ヲ郢ァ蜈キ�シ貅伉ツ髣搾スヲ陟�ソス�定ャ壽㈱��陷�スコ邵コ蟶呻ス狗クコ�ス
- 郢昜サ」ホ。郢晢スシ陷企宦�ー諠ケ�ス阮吶定ア包スィ騾カ�ョ邵コ�ョGaN邵イ竏壹Τ郢晢スッ郢晢スシ郢ァ�「郢晢スウ郢晏干繝ヲ郢ァ�ケ郢晏現�ス髫ア�イ鬯伜セ娯�隴崢鬩包スゥ邵コ�ェ郢ァ�「郢晏干ホ溽ケ晢スシ郢晢ソス
Special Contents 1
- PR -記事ランキング
- DRAM業界をかき乱す中国勢、DDR4の供給の行方は?
- 半導体市場25年は予想以上に伸びるが26年はメモリが失速? ―― WSTS春季予測考察
- 微細化前倒しや3層積層の強化……「市場で勝ち切る」ソニーの半導体戦略
- イメージセンサー金額シェア60%目標「数年遅れる」、ソニー半導体
- センサーで微細プロセス、ロジックも12nm導入へ ソニーのイメージセンサー戦略
- 自動運転のキーデバイスとなる車載SoC
- キオクシアが攻める「NANDとDRAMのあいだ」 NVIDIAと協業も
- 次はデータセンター 「スマホ以外」にも手を広げるQualcomm
- ソニーが「最速」のSPAD距離センサー開発、自動運転L3以上へ
- AMDがAI新興Untether AIのエンジニアチーム「だけ」買収


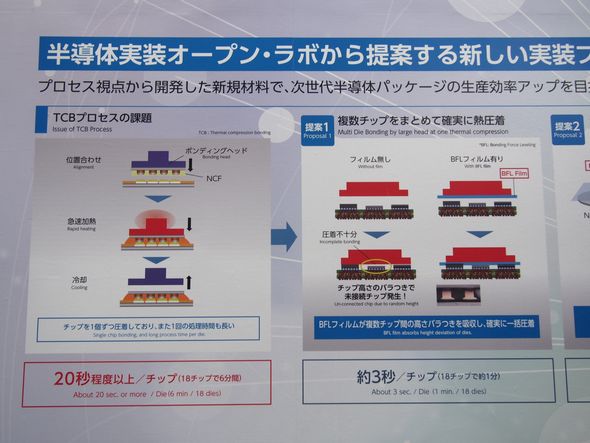

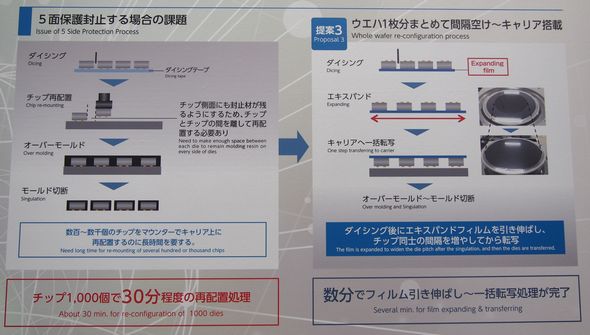
 製造コスト「数十分の1」、卓上半導体工場
製造コスト「数十分の1」、卓上半導体工場 GaN-MOSFET向けゲート絶縁膜プロセス、東芝が開発
GaN-MOSFET向けゲート絶縁膜プロセス、東芝が開発 チップ部品の実装も可能なフィルム型コネクター
チップ部品の実装も可能なフィルム型コネクター TSMCの高性能・高密度パッケージング技術「CoWoS」(前編)
TSMCの高性能・高密度パッケージング技術「CoWoS」(前編) パナソニック、低温硬化性の実装補強材を開発
パナソニック、低温硬化性の実装補強材を開発 モノリシック3D IC、将来有望ながら課題は山積
モノリシック3D IC、将来有望ながら課題は山積




