チャージングダメージの障壁を乗り越えた日米の情熱:湯之上隆のナノフォーカス(4) ドライエッチング技術のイノベーション史(4)(2/5 ページ)
1)トリガーとなった日本人による三つの先駆的研究
筆者らは、「グーグルスカラー」を用いて、いつ、誰が、チャージングダメージの研究を発表したかを調査した。その結果、1991年にUniversity of California, Berkeley(UCB)のH. Shinらが学会2)および論文3)発表を行っていること、1992年にStanford Univ. (University)のS. Fangらが同じく学会4)および論文5)発表を行っていることが分かった。
2) H. Shin, Symp. VLSI Tech. Dig. Papers, (1991).
3) H. Shin, et.al., IEEE Electron Device letters, 12, Issue 8 (1991).
4) S. Fang, et.al., IEDM Technical Digest, (1992).
5) S. Fang, IEEE Electron Devices Letters, 13, Issue 6, (1992).
そして、これら米大学の二つの学会発表と二つの論文が、いずれも、以下に示す日本人による三つの論文を引用文献に挙げていた。
- 吉田幸正、渡辺徹 (東芝)、「反応性イオンエッチング(RIE)によるゲート破壊現象」、DPS、1983年6)
- 川本佳史(日立)、「プラズマエッチングによるゲート絶縁膜破壊」、DPS、1985年7)
- 津国和之、野尻一男他(日立)、「ドライエッチング時のチャージアップがゲート酸化膜破壊に及ぼす影響」、SSDM、1987年8)
6) Y.Yoshida and T.Watanabe (IC Division, Toshiba), “Gate Breakdown Phenomena during Reactive Ion Etching”, Proceedings of 5th Symposium on Dry Process, p.4 (1983).
7) Y.Kawamoto (Central Research Lab., Hitachi), “MOS Gate Insulator Breakdown Caused by Exposure to Plasma”, Proceedings of 7th Symposium on Dry Process, p.132 (1985).
8) K. Tsunokuni, K. Nojiri, S. Kuboshima, and K. Hirobe (Hitachi), “The Effect of Charge Build-up on Gate Oxide Breakdown during Dry Etching”, Extended Abstracts of the 19th Conference on Solid State Devices and Materials, Tokyo, p.195 (1987).
なお、DPSは「Dry Process Symposium」の略で、1979年に日本人が設立したドライエッチング技術の学会である9)。また、SSDMは「Solid State Devices and Materials」の略で、1969年にやはり日本人が設立した半導体デバイスの学会である10)。DPSもSSDMも当時は、日本の国内学会の色が濃かったため、グーグルスカラーの検索には引っ掛からなかったと思われる。
9)1979年から始まったDPS。2018年11月13〜15日に名古屋大学で40周年記念大会が開催される(参考)。
10) 1969年から始まったSSDMは、2018年9月9〜13日に東京大学で50周年記念大会が開催された(参考)。
筆者らはこれらの論文を入手して精査した。その結果、この三つの論文が、チャージングダメージの先駆的研究であると判断した。以下に1〜3の研究内容を簡単に紹介する。
1.東芝の吉田&渡辺論文(1983年のDPS)
恐らく、これが世界で初めてのチャージングダメージに関する論文である。東芝の吉田と渡辺は、平行平板型RIE装置で多結晶Siのゲート電極加工を行うと、トランジスタのゲート絶縁膜が破壊することを報告した。
そして、その原因が、RIE装置の高周波(RF)電源とウエハーの間にあるブロッキングコンデンサーに電荷が蓄積され、ゲートエッチング終了時にプラズマをOFFした瞬間に、ゲート絶縁膜に大きな電位差が発生することに起因すると結論した(図2)。
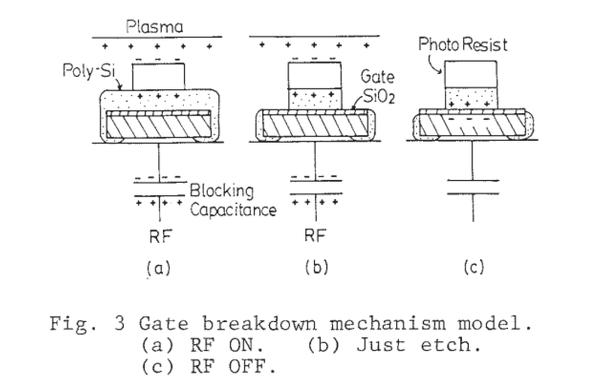 図2:東芝の吉田&渡辺論文(1983年DPS) (クリックで拡大) 出典:Y.Yoshida and T.Watanabe , Proceedings of 5th Symposium on Dry Process, p.4 (1983).
図2:東芝の吉田&渡辺論文(1983年DPS) (クリックで拡大) 出典:Y.Yoshida and T.Watanabe , Proceedings of 5th Symposium on Dry Process, p.4 (1983).2.日立の川本論文(1985年DPS)
日立の川本は、チャージングダメージの評価方法を提案した。まず、MOSやMNOSキャパシターを準備する(図3)。次に、これらをプラズマに照射した後、サンプルに電圧を印加して容量の変化を測定する。そして、そのフラットバンド電圧の変化(ΔVFB)から、SiとSiO2の界面付近に蓄積する電荷量を見積もった。
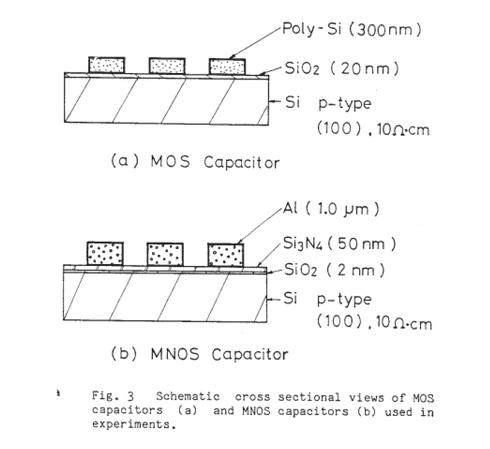 図3:日立の川本論文(1985年DPS) (クリックで拡大) 出典:Y.Kawamoto , Proceedings of 7th Symposium on Dry Process, p.132 (1985).
図3:日立の川本論文(1985年DPS) (クリックで拡大) 出典:Y.Kawamoto , Proceedings of 7th Symposium on Dry Process, p.132 (1985).川本は、マイクロ波プラズマ、平行平板プラズマ、バレル型プラズマに照射したサンプルのΔVFBを測定し、ゲート絶縁膜破壊が界面電荷に起因していると結論した。
3.日立の津国&野尻論文(1987年のSSDM)
日立の津国と野尻らは、川本の手法を使って、ゲート酸化膜が薄くなると絶縁破壊が起きやすくなることを明らかにした(図4)。さらに、その絶縁破壊は、ウエハーに印加された電圧ではなく、プラズマから流れ込む電流によるものであることを解明した。
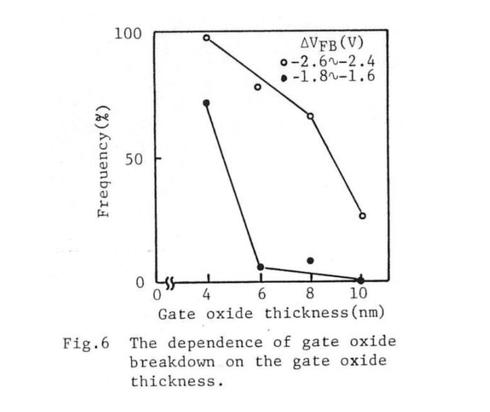 図4:日立の津国&野尻論文(1987年SSDM) (クリックで拡大) 出典:K. Tsunokuni, K. Nojiri et al., 19th Conference on Solid State Devices and Materials, p.195 (1987).
図4:日立の津国&野尻論文(1987年SSDM) (クリックで拡大) 出典:K. Tsunokuni, K. Nojiri et al., 19th Conference on Solid State Devices and Materials, p.195 (1987).また、この論文には記載されていないが、野尻のグループは、精力的にチャージングダメージの研究を続け、日立笠戸工場(現日立ハイテクノロジーズ)のマイクロ波プラズマ装置、米Applied Materials(AMAT)のマグネトロンRIEや米Lam Research(Lam)の誘導結合型プラズマ装置、東京エレクトロン(TEL)のマグネトロンRIEや平行平板型プラズマ装置と、ほとんど全てのドライエッチング装置のチャージングダメージを評価し、その原因を追究したという。そして、その結果を1988年に、装置メーカーにフィードバックしたとのことである。さらに、1993年には、種々のドライエッチング装置のチャージングダメージの評価結果、チャージングダメージのメカニズムおよび対策を記載した論文を米国JVSTで出版している15)。
15) K.Nojiri and K.Tsunokuni, “Study of gate oxide breakdown caused by charge buildup during dry etching”, J. Vac. Sci. Technol., B 11 (5), p.1819 (1993).
1980〜1990年にかけて、DRAMを代表とする半導体産業では、東芝や日立など日本企業がトップランナーだった。それ故、日本が米国よりも早くチャージングダメージの壁に直面し、米国に先んじて先駆的研究を行うことになったのだろう。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 重量はクジラ級! 超巨大な高NA EUV装置の設置をIntelが公開
- どうする? EVバッテリー リサイクルは難しい、でもリユースにも疑問
- パワー半導体向けウエハー市場、2035年に1兆円台へ
- 2023年の世界半導体売上高ランキングトップ20、NVIDIAが初の2位に
- 「GPT-4」を上回る性能で、グラフィカルな文書を読解するLLM技術
- Intelが高NA EUV装置の組み立てを完了、Intel 14Aからの導入に向けて前進
- 中国政府の「Intel/AMD禁止令」、中国企業への強い追い風に
- JDI、次世代有機ELディスプレイ「eLEAP」を24年12月に量産開始へ
- Intelの最新AI戦略と製品 「AIが全てのタスクを引き継ぐ時代へ」
- TSMC、24年Q1は増収増益 地震の影響は「最小限にとどまる」
