従来比1/30のコストでライン構築できる接合技術:「SEMICON JAPAN 2015」で日本初の展示
コネクテックジャパンは、「SEMICON JAPAN 2015」に、ダメージフリー接合技術とデスクトップ型フリップチップボンダーを日本で初めて展示すると発表した。
基板の材料側にバンプを形成
コネクテックジャパンは、2015年12月16~18日に東京ビッグサイトで開催される「SEMICON JAPAN 2015」に、ダメージフリー接合技術「Monster PAC Technology」と、デスクトップ型フリップチップボンダーを日本で初めて展示すると発表した。
現行の接合技術はウエハー側にバンプを形成し、ウエハー工程での作り込みが必要になる。そのため、対応する設備も前工程用の設備が必要となり、工期が長く高コストになるという欠点があった。また、バンプの材料がはんだやスズ/銅を用いるため、基板との接合に260~270℃という高い温度と荷重が必要になり、物理的なダメージに弱いデバイスに対して深刻な影響を与えてしまう欠点もあった。
Monster PAC Technologyは、これらの欠点を解決する低温低圧の実装技術という。印刷工法を工夫することで、基板側に銀ペーストによるバンプを形成。接合の強度を保ちつつ、低い温度(170℃)と荷重で接合することを可能にしたという。「IoTや5Gで多様化/複雑化するニーズに対して、従来型の大量生産ラインでは対応が不可能なパッケージを、開発から量産まで低コストで対応することが可能になる」(同社)と語る。
同社は、Monster PAC Technologyにより、フリップチップボンダーをデスクトップサイズまで小型化/低価格化することを可能にしている。クリーンルームも不要になるため従来比1/30のコストでパッケージラインを構築できるとした。
Copyright © ITmedia, Inc. All Rights Reserved.
Special Contents
- PR -- EE Times Japanテ勇DN Japan 邨ア蜷磯崕蟄千沿�壼刈騾溘☆繧九後ぎ繝ゥ繧ケ蝓コ譚ソ縲埼幕逋コ縲譌・譛ャ繧ゅ¢繧灘シ募スケ縺ォ窶補� 髮サ蟄千沿2025蟷エ4譛亥捷
- 髢狗匱繧堤ー。邏�蛹悶@遶カ莠牙鴨繧貞シキ蛹悶☆繧九∫ャャ4荳紋サ」豎守畑USB繝�ヰ繧、繧ケ繧ウ繝ウ繝医Ο繝シ繝ゥ繝シ縺ョ螳溷鴨
- 蜊雁ー惹ス謎ク崎憶隗」譫舌�譁ー蠅�慍縲√�繝ュ繧サ繧ケ髢狗匱繧貞刈騾溘☆繧区ャ。荳紋サ」縺ョ3D X邱夐。募セョ髀。縺ョ螳溷鴨
- 縲悟屓謚倥さ繝ウ繝医Λ繧ケ繝医ヨ繝「繧ー繝ゥ繝輔ぅ縲阪r遐皮ゥカ螳、繝ャ繝吶Ν縺ァ螳溽樟縺吶k譁ケ豕輔→縺ッ��
- 蜊雁ー惹ス灘膚遉セ 讌ュ邵セ縺セ縺ィ繧√�2025蟷エ3譛域悄隨ャ3蝗帛濠譛溘�
Special Contents 2
- PR -記事ランキング
- 半導体メーカーの「悲喜こもごも」 絶好調のTSMC、人員削減のST
- IntelがAltera売却へ、株式51%を米投資ファンドに
- 2024年の半導体市場は21%成長 NVIDIAが初の首位に
- ミネベアミツミが芝浦電子買収へ 「8本槍」戦略強化に向け
- 2035年のウエハー需要を予測する ~半導体も「VUCA時代」に
- 1インチサイズの全固体電池を10秒で作製 レーザーで加工
- AIのデータ転送問題解決に王手、シリコンフォトニクス新興企業
- トランプ政権の「アメとムチ」 Intelは補助金を受け取れるのか
- チップに「水路」を作り冷却液を流し込む 高効率に放熱
- 世界半導体市場が10カ月連続で17%以上成長 2月として過去最高に


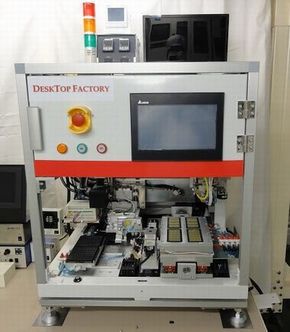
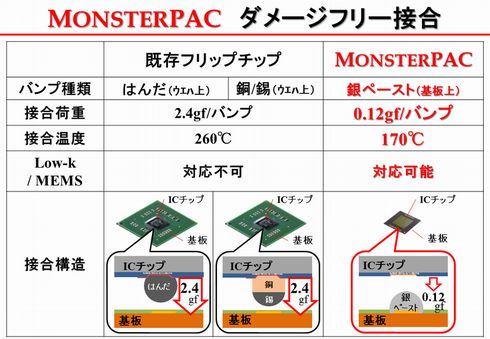
 IoTを原動力に復活狙う日本半導体産業――SEMICON Japan2015
IoTを原動力に復活狙う日本半導体産業――SEMICON Japan2015 IoTによる200mmファブの復活――SEMIが語る
IoTによる200mmファブの復活――SEMIが語る 300mmウエハー対応のバンプ形成技術「IMS」
300mmウエハー対応のバンプ形成技術「IMS」 IoT市場を支える4~8インチ対応のFEB測長装置
IoT市場を支える4~8インチ対応のFEB測長装置




