20μmピッチTSV、車載用測距センサーに適応へ:SEMICON Japan 2015 会場レポート
新エネルギー・産業技術総合開発機構(NEDO)は、2015年12月16~18日の会期で東京ビッグサイトで開催されている「SEMICON Japan 2015」で、車載センサー向け3次元積層技術を展示した。
新エネルギー・産業技術総合開発機構(NEDO)は2015年12月16日に開幕した展示会「SEMICON Japan 2015」(東京ビッグサイト/2015年12月16~18日)で、IT/エレクトロニクス分野の研究開発成果や実用化事例を展示している。テーマは、「IoT/CPSに貢献する電子デバイス」。本記事では、次世代車載用センシングデバイス向け3次元積層技術を紹介する*)。
*)関連記事:SEMICON Japan 2015、NEDOは何を展示する?
1チップあたり4万9000個のバンプ接続
自動運転の実現に向けて、高速処理性能を備えつつ、小型、低消費電力を実現したセンシングデバイスが必要となる。自動車の周囲環境を検知する測距センサーも高性能、小型、低消費電力の同時実現が求められるセンサーの1つだ。
光検出型の測距センサーの性能を高めるには、各受光素子からの信号を遅延なく信号処理回路へと伝達することが重要だ。NEDOは、その実現手段として「(受光素子などで構成する)センサーLSIと信号処理LSIを3次元に積層し、両LSI間をTSV(Through Silicon Via)を介して接続する構造が理想的」としている。同研究は、車載の品質要求に応えるTSV構造の開発と3次元積層プロセス技術の開発を行っている。
NEDOの資料によると、2015年9月30日時点で、障害物の位置と距離を同時に測定できるセンシングデバイス、省スペース化を可能にするデバイスの小型化技術の技術的見通しが立ったとしている。信号処理はマルチコア技術により、20フレーム/秒(fps)以上を達成。Cuメッキ埋め込み構造では、20μmピッチTSVの導通を実現した。20μmピッチは車載用としても問題ない値で、耐圧(40V)も問題ないことを確認しているという。
チップ積層では、1チップあたり4万9000個のバンプ接続を実現。「温度評価サイクルと高温放置を行って、車載信頼性で問題ないことも確認済みである」(説明員)と語る。また、新しい工法/構造を採用したことにより、プロセス時間の30%削減と7μmのバンプ形成も可能にした。これにより、コスト削減にもつながるという。
なお、3次元積層技術の開発は、NEDOの「次世代スマートデバイス開発プロジェクト」(2013~2017年度)で行われている。プロジェクト参加機関は、ラピスセミコンダクタ、デンソー、住友精密工業、ルネサス エレクトロニクス、産業技術総合研究所。
現在は、高信頼性が期待できる構造、コスト低減が期待できる構造、初期特製評価が容易な構造の3種類のTSVを検討しているという。プロジェクトが終わる2017年までに、環境変化(使用時間や温度の変化)に適応するかどうかの実証実験を行うとしている。
Copyright © ITmedia, Inc. All Rights Reserved.
Special Contents
- PR -Special Contents 1
- PR -Special Contents 2
- PR -記事ランキング
- 2024年の半導体市場は21%成長 NVIDIAが初の首位に
- 半導体メーカーの「悲喜こもごも」 絶好調のTSMC、人員削減のST
- IntelがAltera売却へ、株式51%を米投資ファンドに
- 1インチサイズの全固体電池を10秒で作製 レーザーで加工
- ミネベアミツミが芝浦電子買収へ 「8本槍」戦略強化に向け
- 2035年のウエハー需要を予測する ~半導体も「VUCA時代」に
- ソフトバンクが買収したAmpereの「流転の生涯」をたどる
- トランプ政権の「アメとムチ」 Intelは補助金を受け取れるのか
- AIのデータ転送問題解決に王手、シリコンフォトニクス新興企業
- パワー半導体市場、25年後半に在庫が正常化 26年から成長拡大


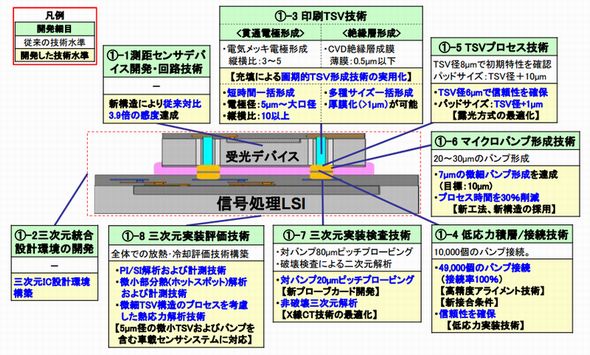
 CMOSイメージセンサーが引っ張る3次元積層技術
CMOSイメージセンサーが引っ張る3次元積層技術 世界半導体製造装置市場、2016年は1.4%増へ
世界半導体製造装置市場、2016年は1.4%増へ IoTを原動力に復活狙う日本半導体産業――SEMICON Japan2015
IoTを原動力に復活狙う日本半導体産業――SEMICON Japan2015 次世代3次元SoCは、TSVを使わない――Qualcomm
次世代3次元SoCは、TSVを使わない――Qualcomm