EE Times Japan >
プロセス技術 >
「SEMICON West 2016」、7nm世代以降のリソグラフ...
「SEMICON West 2016」、7nm世代以降のリソグラフィ技術(ASML編):福田昭のデバイス通信(88)(2/2 ページ)
» 2016年09月14日 10時30分 公開
[福田昭,EE Times Japan]
急速に下がってきたマスクの欠陥密度
EUVリソグラフィが抱える大きな課題に、マスク(レチクル)の欠陥がある。これについてLercel氏はかなり積極的な見解を示していた。過去6年ほど、「1年で10分の1」という速いペースで欠陥密度は低下してきた。2010年の欠陥密度に対して2015年の欠陥密度はおよそ1万分の1に下がっている。このペースが今後も続くのであれば、未来は明るい。
最大の課題「光源の出力」がついに向上してきた
そしてもう1つの重要な課題で、最大の課題とされてきた光源の出力が、ついに上昇してきた。最近まで光源の出力は思うように上がらず、このためにスループットが実用的な要求仕様よりもはるかに低いままにとどまっていた。
それが現在では3年前の2倍以上、125Wを実現できている。125Wの光源による露光装置のスループットは300mmウエハーで1時間当たり85枚を達成しており、目標である125枚/時間にぐっと近づいた。開発段階の光源出力は200Wに達しており、ASLMは次期のEUV露光装置に、この高出力光源を搭載する予定である。最大出力では210Wに到達するもようだ。
2018年~2019年には7nm世代のロジック半導体の量産が始まるとASMLは想定している。7nmロジックは、ArF液浸とEUVの組み合わせ(いわゆる「ミックス・アンド・マッチ」)で乗り切る構えだ。
(次回に続く)
関連記事
Copyright © ITmedia, Inc. All Rights Reserved.
Special Contents
- PR -Special Contents
- PR -Special Contents 1
- PR -Special Contents 2
- PR -記事ランキング
- TSMCがGaN事業撤退へ、ロームは「さまざまな可能性を協議」
- 講演会場が静まり返った――中国が生み出した衝撃のトランジスタ構造
- TSMCがGaNファウンドリー事業から撤退へ、NavitasはPSMCと提携で対応
- 26年度には世界大手の9割が採用、黒字化も 本格化するソニーの車載イメージセンサー
- 25年5月の世界半導体市場は全地域で成長、19.8%増の590億ドルに
- 危うい再建計画 Wolfspeed、CHIPS法補助金で再生図るか
- 半導体製造ラインの立ち上げ迅速に、日本IBMが京都に開発拠点
- 「DRAM生産の4割を米国で」 Micronを待ち受ける過酷な競争
- Qualcommの狙いは何なのか、やたらと「高い」Alphawave買収額
- 22nmプロセス採用でMRAM内蔵、ルネサスがエッジAI特化の新マイコン


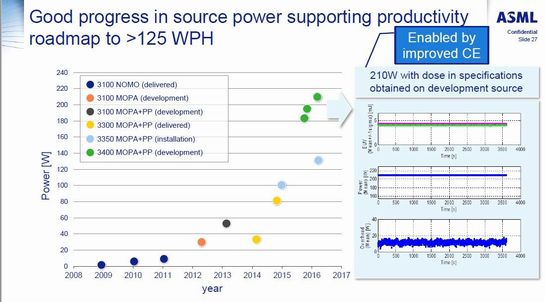
 「SEMICON West 2016」、7nm世代以降のリソグラフィ技術(東京エレクトロン編)
「SEMICON West 2016」、7nm世代以降のリソグラフィ技術(東京エレクトロン編) 「SEMICON West 2016」、7nm世代以降のリソグラフィ技術(ニコン編)
「SEMICON West 2016」、7nm世代以降のリソグラフィ技術(ニコン編) ASMLがEUVリソグラフィ開発の最新状況を公表(1)~ArF液浸の限界
ASMLがEUVリソグラフィ開発の最新状況を公表(1)~ArF液浸の限界 着実に進歩するEUV、課題は光源
着実に進歩するEUV、課題は光源 ASMLがEUV装置を15台受注、納品先はIntel?
ASMLがEUV装置を15台受注、納品先はIntel? IEDMで発表されていた3D XPointの基本技術(前編)
IEDMで発表されていた3D XPointの基本技術(前編)