Samsungが次世代2.5D実装技術「I-Cube4」を発表:ロジックと4個のHBMを積層
Samsung Electronics(以下、Samsung)は2021年5月6日(韓国時間)、2.5D(2.5次元)パッケージング技術「I-Cube4」(Interposer-Cube4/アイキューブ4)の提供を開始したと発表した。
Samsung Electronics(以下、Samsung)は2021年5月6日(韓国時間)、2.5D(2.5次元)パッケージング技術「I-Cube4」(Interposer-Cube4/アイキューブ4)の提供を開始したと発表した。
Samsungの「I-Cube」は、1個または複数個のロジックダイとHBM(High Bandwidth Memory)ダイを、シリコンインターポーザー上に積層する実装技術。これにより、複数のダイを1チップとして、1パッケージに搭載することができる。
I-Cube4は、1個のロジックダイと4個のHBMダイを積層したもので、HPC(High Performance Computing)からAI(人工知能)、5G(第5世代移動通信)、大規模データセンター向けチップへの適用を目指す。
インターポーザーの面積は、ロジックダイやHBMダイの個数が増加するとそれに伴って増加する。I-Cubeで使われるインターポーザーの厚さは100μmと紙よりも薄いため、インターポーザ―の面積が大きくなると、曲がってしまい、チップの質に悪影響を与える可能性があるという。Samsungは、材料や厚さを変えることで、インターポーザ―の反りや熱膨張を制御する方法を研究し、I-Cube4の実用化に成功したと説明する。
さらに、効率的に放熱できるよう、I-Cube4向けに独自のモールドフリー構造を開発した。
Samsungは2018年に「I-Cube2」、2020年に「X-Cube(eXtended-Cube)」を発表している。I-Cube2は1個のロジックダイと2個のHBMダイを集積する技術で、X-CubeはロジックダイとSRAMを垂直に積層する技術である。
Copyright © ITmedia, Inc. All Rights Reserved.
スポンサーからのお知らせ
- PR -Special Contents 2
- PR -記事ランキング
- 世界半導体製造装置市場、2026年は過去最高に
- 2025年は数年に一度の「ビッグチェンジ」イヤー、NVIDIAとAMDの最新GPUを分解
- 「過去の投資は過剰だった」 Intel、ドイツとポーランドの新工場計画を中止
- ついにできた!Rapidus試作ライン稼働、2nm GAAトランジスタの動作を確認
- ウシオ電機、オスラムグループのランプ事業を買収
- 車載SiCモジュール強化の三菱電機、独自モジュール「J3」の新製品投入へ
- ルネサス、Wolfspeed再建支援で25年上期は1753億円の赤字
- 第9世代BiCS FLASH適用512Gb TLC製品、キオクシアがサンプル出荷
- GaN撤退のTSMC、その後の戦略を考察する
- HBMと同等コストで記憶容量8倍、サンディスクが「HBF」推進強化


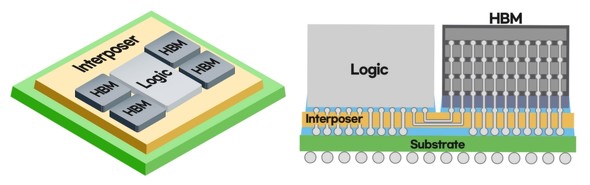
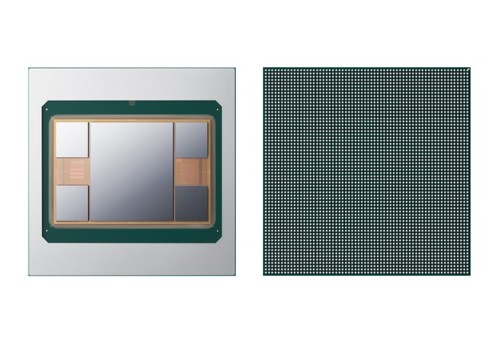
 2.5D(2.5次元)の新世代パッケージング技術
2.5D(2.5次元)の新世代パッケージング技術 ムーアの法則 次なるけん引役は「チップレット」 ~IEDM2020に見る先端パッケージ技術
ムーアの法則 次なるけん引役は「チップレット」 ~IEDM2020に見る先端パッケージ技術 TSMCの高性能・高密度パッケージング技術「CoWoS」(前編)
TSMCの高性能・高密度パッケージング技術「CoWoS」(前編) Intelの高性能・高密度パッケージング技術「EMIB」の概要
Intelの高性能・高密度パッケージング技術「EMIB」の概要 TSMCが90億ドルの資金調達へ、日本に子会社設立も
TSMCが90億ドルの資金調達へ、日本に子会社設立も









